| §1はじめに Si MOS FETやGaAs/AlGaAsヘテロ構造界面中に形成される2次元電子系は、極低温強磁場下において整数量子ホール効果(IQHE)とよばれる量子現象を示す。IQHE状態においては、サンプルのホール抵抗RHはh/ie2(iはFilling factor)というユニバーサルな値に量子化され、同時に縦抵抗はほぼゼロになる。 さてこのIQHE状態にあるサンプルについて流す電流を増大させると、図1のようにある臨界電流値で突然IQHE状態は崩壊して縦抵抗は急増大し、ホール抵抗も量子化値からずれる。この現象をIQHEのブレークダウン現象という。ブレークダウン現象のメカニズムについてはこれまで多くの実験的、理論的研究がなされてきたが、発見から10年以上が過ぎた現在でもまだ完全には明らかになっていない。 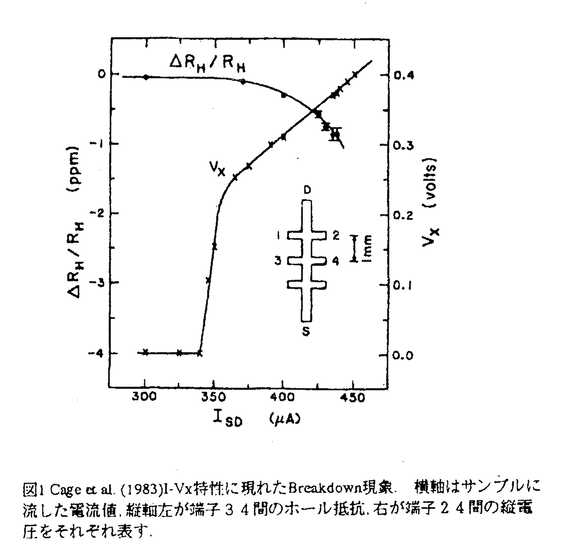 図1 Cage et al.(1983)I-Vx特性に現れたBreakdown現象.横軸はサンプルに流した電流値,縦軸左が端子34間のホール抵抗,右が端子24間の縦電圧をそれぞれ表す.§2本研究の目的 図1 Cage et al.(1983)I-Vx特性に現れたBreakdown現象.横軸はサンプルに流した電流値,縦軸左が端子34間のホール抵抗,右が端子24間の縦電圧をそれぞれ表す.§2本研究の目的 我々のグループでは1985年に、このブレークダウン現象のメカニズムとしてブートストラップ式電子加熱モデル(BSEH)を提案した。ブレークダウン現象についての多くのモデルは、ホール電圧EHがある臨界電場ECを越えたときに電気電導率 xxが急増大するような微視的メカニズムを考えている。これに対して、BSEHは絶対零度でも生じうる電子系の熱的安定条件の破れこそがブレークダウン現象の原因であるという、他のモデルとは根本的に異なるメカニズムを主張している。本研究では他の多くのモデルとBSEHで大きな違いが生じると予想されるブレークダウン現象のチャネル長さ依存性を、実験的に調べることによってブレークダウン現象のメカニズムを明らかにすることを目的としている。 xxが急増大するような微視的メカニズムを考えている。これに対して、BSEHは絶対零度でも生じうる電子系の熱的安定条件の破れこそがブレークダウン現象の原因であるという、他のモデルとは根本的に異なるメカニズムを主張している。本研究では他の多くのモデルとBSEHで大きな違いが生じると予想されるブレークダウン現象のチャネル長さ依存性を、実験的に調べることによってブレークダウン現象のメカニズムを明らかにすることを目的としている。 この要旨中では詳しく触れるスペースがないが、過去の実験報告ではブレークダウン臨界電流値ICのサンプル幅依存性について、ICがサンプル幅に対してLinearな依存を示す例とSublinearな依存を示す例の2つのカテゴリーが知られている。本研究では多くの報告例の存在するLinearな依存を示すブレークダウン現象の機構を解明することを主眼として実験を進めた。ただし予備的にSublinearな依存を示す例についても実験をおこなっている。また、ブレークダウン現象が生じる電流値よりも数十倍大きな電流領域における2次元電子系の振る舞いを調べるための実験をおこなった。 §3実験方法 実験はGaAs/AlGaAsヘテロ構造を持った複数の4種類のWaferを用いておこなった。我々の「チャネル長さ依存性」を調べる実験は大きく分けて3つの部分から構成されている。まず全く同一の形状のサンプルを異なる4つのWaferから作成し、それぞれについてブレークダウン臨界電流値のサンプル幅依存性を調べた。次にその中で臨界電流値がLinearな依存を示すWaferについて、チャネル長さが10 mから300 mから300 mにいたる数種類の「くびれ型」のサンプル(図3(a))と「Hall-bar型」のサンプル(図3(b))を作成し、それぞれで生じるブレークダウン現象を測定した。これによりブレークダウン現象のチャネル長さ依存性が明らかになった。またブレークダウン現象の動的なメカニズムについて、すなわち電子がチャネル内をある程度の距離走らなければブレークダウン現象が生じないはずだとするBSEHの予想を確かめるために、チャネルの端に電圧プローブ対をつけたサンプル(図3(c))を作成し実験をおこなった。 mにいたる数種類の「くびれ型」のサンプル(図3(a))と「Hall-bar型」のサンプル(図3(b))を作成し、それぞれで生じるブレークダウン現象を測定した。これによりブレークダウン現象のチャネル長さ依存性が明らかになった。またブレークダウン現象の動的なメカニズムについて、すなわち電子がチャネル内をある程度の距離走らなければブレークダウン現象が生じないはずだとするBSEHの予想を確かめるために、チャネルの端に電圧プローブ対をつけたサンプル(図3(c))を作成し実験をおこなった。 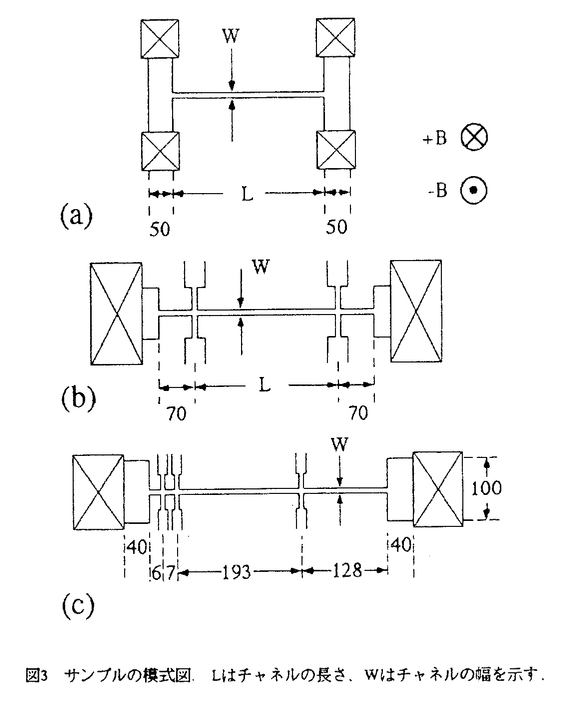 図3サンプルの模式図.Lはチャネルの長さ.Wはチャネルの幅を示す.§4実験結果 図3サンプルの模式図.Lはチャネルの長さ.Wはチャネルの幅を示す.§4実験結果 まず4種類のWaferによる同一形状のサンプルによる臨界電流値のサンプル幅依存性の実験で2種類がLinearな依存を示し、残りの2種類がSublinearな依存を示した。これは「Linear」と「Sublinear」の違いがWafer固有の性質に由来するものであることを意味する。次にLinearな依存を示すWaferの一つについて、幅は同じでチャネルの長さの異なる複数のサンプルを使って長さ依存性を調べた実験結果を図4に示す。 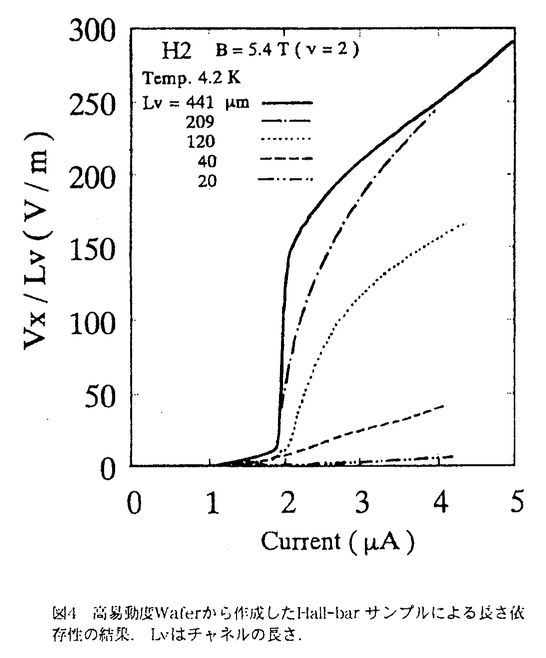 図4 高易動度Waferから作成したHall-barサンプルによる長さ依存性の結果.Lvはチャネルの長さ. 図4 高易動度Waferから作成したHall-barサンプルによる長さ依存性の結果.Lvはチャネルの長さ. 図を見ればわかるように、長さが短いサンプルになるほどブレークダウン現象の特徴である臨界電流値での縦電圧急増大が消えていくという明確な結果が得られた。この結果は易動度が低いもう一方のLinearな依存を示すWaferから作成したサンプルについても、定性的に再現した。同一の幅を持つサンプルでは長さが違っても、同じ電流値ならばホール電場の大きさは同じであるはずである。したがってこの結果は、ブレークダウン現象がホール電場の絶対的な大きさにはよらないものであることを解釈抜きに示す。 次に図3(C)のサンプルによる実験結果を図5に示す。このような電流極性に対する極端に非対称なI-Vx特性は幅の広いサンプル(W=20 m)でも再現し、また低易動度のサンプルについても定性的には同様な結果が得られた。この結果はBSEHによって次のように解釈できる。BSEHではブレークダウン現象を電子系全体のエネルギーバランスで考える、すなわち電子系の有効電子温度をTeとしたときに、電子系のEnergy gain rate GとEnergy loss rate Lについて電子系の安定化条件と考えられる m)でも再現し、また低易動度のサンプルについても定性的には同様な結果が得られた。この結果はBSEHによって次のように解釈できる。BSEHではブレークダウン現象を電子系全体のエネルギーバランスで考える、すなわち電子系の有効電子温度をTeとしたときに、電子系のEnergy gain rate GとEnergy loss rate Lについて電子系の安定化条件と考えられる  が満たされる、「低い電子温度の状態」と「高い電子温度の状態」の間の遷移こそがブレークダウン現象と考える。さてこの遷移は、電子-電子衝突によるMultiplicationで達成されると我々は考えている。つまり電子がある程度の距離チャネル内を旅して電子-電子衝突を繰り返すことでブレークダウン現象が生じるのだという描像である(図6)。したがって図5でチャネルの電子注入端から電圧プローブ対が遠い場合にはブレークダウン現象が観測できるのに対して、チャネルの電子注入端から電圧プローブ対が近い場合には、十分なMultiplicationが達成できずブレークダウン現象が観測できないという結果が得られたのだとBSEHでは解釈される。 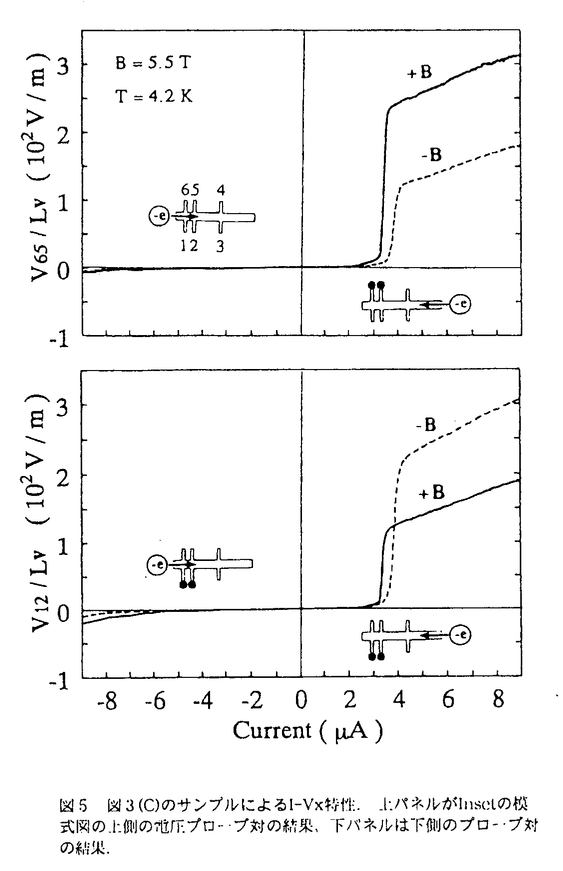 図5 図3(C)のサンプルによるI-Vx特性.上パネルがInsetの模式図の上側の電圧プローブ対の結果、下パネルは下側のプローブ対の結果. 図5 図3(C)のサンプルによるI-Vx特性.上パネルがInsetの模式図の上側の電圧プローブ対の結果、下パネルは下側のプローブ対の結果.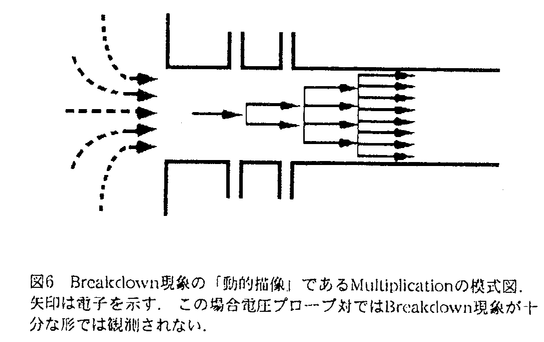 図6 Breakdown現象の「動的描像」であるMultiplicationの模式図.矢印は電子を示す.この場合電圧プローブ対ではBreakdown現象が十分な形では観測されない. 図6 Breakdown現象の「動的描像」であるMultiplicationの模式図.矢印は電子を示す.この場合電圧プローブ対ではBreakdown現象が十分な形では観測されない. ホール電圧EHがある臨界電場ECを越えたときに電気電導率 xxが急増大するような微視的メカニズムを考えようとする他のモデルではこの実験結果を満足に説明することは不可能であり、「Linearな依存」を示すブレークダウン現象のメカニズムはBSEHmodelが適切であるという強い証拠であると考える。 xxが急増大するような微視的メカニズムを考えようとする他のモデルではこの実験結果を満足に説明することは不可能であり、「Linearな依存」を示すブレークダウン現象のメカニズムはBSEHmodelが適切であるという強い証拠であると考える。 また「Linearな依存」を示す高易動度Waferについてブレークダウン臨界電流密度の数十倍にいたる高電流密度領域にいたるまでI-Vx特性を測定した。その結果、ブレークダウン現象とは独立の指数関数的な縦電圧増大をはじめて発見した。これは、ブレークダウン現象のメカニズムとして過去に提案されたLandau level間のZener type tunnelingによる縦電圧の増大ではないかと考えている(図7)。 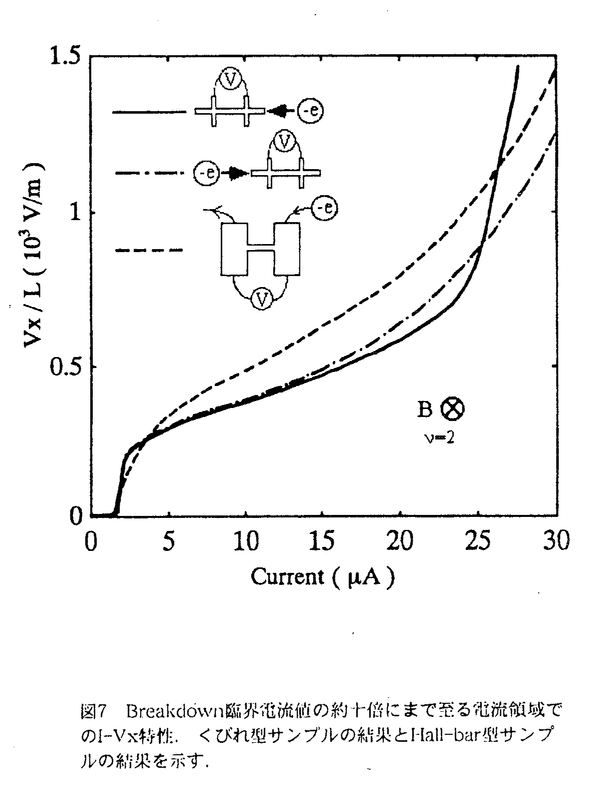 図7 Breakdown臨界電流値の約十倍にまで至る電流領域でのI-Vx特性.くびれ型サンプルの結果とHall-bar型サンプルの結果を示す. 図7 Breakdown臨界電流値の約十倍にまで至る電流領域でのI-Vx特性.くびれ型サンプルの結果とHall-bar型サンプルの結果を示す. 「Sublinearな依存」を示すWaferについても「Linearな依存」を示すWaferでおこなったの場合と同様の趣旨で長さ依存性を調べる実験をおこなった。サンプルは図3(c)と同じようにチャネル端近傍に電圧プローブ対を配置したものを使い、電流極性に対する依存性を調べた。その結果として、「Linearな依存」を示すWaferと類似した電流極性に対する非対称性が得られた。しかし向かい合わせの電圧プローブ対の組について、一方の側の電圧プローブ対がブレークダウン現象的な縦電圧の急増大を測定するのと同じ電流値で、向かい側の電圧プローブ対で縦電場の急降下現象がみられるなど、「Linearな依存」を示す場合とは大きく異なる様相を示した。この実験結果は「Sublinearな依存」を示すブレークダウン現象について、基本的にはBSEHmodelで説明できるものではあるが、巨視的な電荷の不均一性に関連する他のメカニズムが絡んでいる可能性があることを示すものと考えている。 §5まとめ ブレークダウン現象のチャネル長さ依存性を調べることによりブレークダウン現象のメカニズム理解に大きな意味を持つと考えられる現象、すなわちチャネル長さの短いサンプルにおけるブレークダウン現象消滅現象と、ブレークダウン現象が生じるためには、電子がチャネル内をある程度の距離旅しなければならないことを意味する現象を我々は初めて見いだした。ブレークダウン現象のメカニズム理解にとって本研究は大きな意味を持つものと考える。 |