学位論文要旨
| No | 113393 | |
| 著者(漢字) | 須藤,信也 | |
| 著者(英字) | ||
| 著者(カナ) | スドウ,シンヤ | |
| 標題(和) | 分光エリプソメトリによる有機金属気相エピタキシーのその場観察と量子構造成長への応用 | |
| 標題(洋) | ||
| 報告番号 | 113393 | |
| 報告番号 | 甲13393 | |
| 学位授与日 | 1998.03.30 | |
| 学位種別 | 課程博士 | |
| 学位種類 | 博士(工学) | |
| 学位記番号 | 博工第4111号 | |
| 研究科 | 工学系研究科 | |
| 専攻 | 電子工学専攻 | |
| 論文審査委員 | ||
| 内容要旨 | 近年の電子・光デバイスの発展の根底を支えるのは結晶成長技術である。量産性を考えた場合によく用いられるのは有機金属気相エピタキシー(MOVPE:Metal-Organic Vapor Phase Epitaxy)法であるが、ガスの流れや反応が絡んでくるため成長機構が極めて複雑である。そのため膨大な時間と労力を割いた条件出しが必要で、その結果得られるデバイスクオリティの結晶を提供できる成長条件も個々の装置依存性があるのが現状である。それらを独立に行っていては非常に効率が悪くまた最適条件であるかもわからないままである。この現状を打破するために本研究ではMOVPE成長時の成長基板のその場観察を分光エリプソメトリ法を用いて行い、その結果を成長条件決定の一助とし効率の良い論理的な最適成長条件決定手法を得ると共に、その評価結果を成長機構解明の一助とすることも目的とする。 MOVPE法では分子線エピタキシー(MBE:Molecular Beam Epitaxy)法のように高真空を用いる装置ではないのでその場観察の手段として電子線を用いることができず、光学的なプローブを用いたものがほとんどである。本研究で分光エリプソメトリを用いたのは、光学プローブの侵入長内の結晶成長層の組成(誘電率)の評価ができることと、また内部構造がわかっている(もしくは変化しないことがわかる)試料に対しては比較的表面で起こる信号も得ることができるためである。またこれまでの研究は光学的手法を用いて結晶成長の機構解明に重きをおいたものであったが、本研究では実用的な立場から応用範囲を選択して評価結果を利用することにより、結晶成長により得られる試料の特性すなわちヘテロ界面の急峻性を改善することができた。 本研究で用いたMOVPE装置は、分光エリプソメトリ装置のための光学窓を持ち、有機V族材料(TBA:tertiarybutylarsine及びTBP:tertiarybutylphosphine)を用いている。基板回転機構はH2ガスを用いるものでエリプソメトリの測定中も回転させながら測定をしてもほとんど問題ない。この点は他の反射率を直接測定する手法よりも回転起因の雑音に強いエリプソメトリの特長であると言える。分光エリプソメトリは位相変調型を用いたので測定間隔を短くでき、本研究では最小0.2秒で測定を行った。 本研究の対象とした材料系はInPに格子整合したInGaAsP系である。この材料系はヘテロ界面でAs-P置換が生じて界面の急峻性を確保するのが難しいことが一般に知られている。現状ではこの問題を回避するために経験的な条件出しが行われている。本研究では分光エリプソメトリ法によりその場観察することにより、その結果を成長条件決定の一助とすることを考えた。MOVPE成長におけるヘテロ界面の成長は図1に示すようなガス切り換えによって行われる。その際に起こるヘテロ界面の劣化の可能性も同時に示した。このうち次の膜のV原子が前の層に入り込むタイプの場合は主に成長中断中の評価評価を行い、前の膜のV族原子が次の層に入り込むタイプの場合には成長中断中の評価に加え次の膜の成長中の組成を行えばよい。これらの評価は分光エリプソメトリ法を用いることにより可能である。  成長中の組成の評価は次のように用途によって使い分けることが可能である。ある測定時間(1分程度)の間は均一の膜成長が起こっていると仮定できる場合には、薄膜一層モデルから得られる理論式にその測定結果をフィッティングさせ成長組成を求めた後、その結果から時間と膜厚の関係を再びフィッティングによって求めることができる。均一の膜成長が起こっていると仮定できない場合やなるべく即時に成長層の組成を知りたい場合には、供給しているIII族量から見積もられる成長レートを仮定することにより現時点で成長している膜の(等価)誘電率を知ることができる。この手法によって得られたヘテロ界面の劣化の程度と、その試料をTEMによる組成分析法(CAT:Composition Analysis by Thickness-fringe)で評価した結果はほぼ完全に一致することがわかった。 成長中断中の基板からの信号をその場観察する場合は次のように行った。InP,InGaAs成長層上にTBPを導入,TBAを導入,V族を遮断の各状態をつくりエリプソメトリ信号の変化を測定する。その際ガスの流速はほぼ急峻に切り替わる条件にし、基板回転をしながら測定をした。これは実際のデバイス用基板作製時を考慮したのと同時に試料の異方性の測定が可能になるという利点を持つ。回転起因のあおりにより雑音が増加するが、反射強度ほどの大きな変化はおこさず、それ以上の信号の変化が基板回転によって得られる。結果として次のような知見が得られた。 まず、成長温度610℃、成長圧力100mbarにおいて、InP表面からの信号を取得した。有機V族導入した成長中断中に、そのV族を遮断すると信号の絶対値が変化すると同時に信号の振幅が変化した(図2)。これはInP表面のPもしくはTBPの分解生成物が脱離し、それにより表面の異方性が変化したことに由来する。成長温度を400℃台にすると「TBP導入状態」から「V族遮断状態」への変化が緩やかになってくる。よって成長温度610℃では実用的に充分速く表面の過剰なP(Pの分解生成物)は脱離することがわかる。しかしながら、InGaAs表面からはこの成長条件において信号の変化はほとんど得られない(図3)。そこでこの成長温度ではInGaAs表面から過剰なAs(TBAの分解生成物)がパージされないことがわかった。この過剰なAsはInP/InGaAs/InPヘテロ界面を作製する際にInGaAs上のInP層にAsが入り込んでヘテロ界面の急峻性が劣化する原因になる。   この過剰なAsをパージするための手段としてInGaAs上にTBPを導入して強制的に表面のAs-P置換を引き起こすという選択肢も存在する。しかし成長温度610℃成長圧力100mbarにおいて、分光エリプソメトリによりInP上にTBAおよびInGaAs上にTBPを導入した際の変化を測定すると、前者の方は急峻な変化の後、比較的緩やかに変化を始めるのに対して、後者は急激に信号の変化を始めることがわかった。さらにその後、それぞれ元のV族材料を再導入した場合、前者はTBA導入が6sec以内であれば元の信号に戻るのに対して後者の場合はわずかなTBP導入の場合であっても元の信号に戻らない。これはInGaAs上にTBPを導入すると不可逆な変化がInGaAs層に導入されることを意味し、特性改善にはInGaAs上のTBP導入時間(図1の(8)の時間)を少なくする必要があることを示唆している。この事実はこのTBP導入時間を変化させた量子井戸からのPL(Photoluminescence)測定およびTEMによる組成分析法によっても確認でき、InGaAs上に単独でTBPを導入することはInP/InGaAs/InP量子井戸の特性劣化を引き起こすことがわかった。 そこでInGaAs上でTBPを単独で導入することなくInP上での変化(図2)と類似した変化を引き起こす条件を分光エリプソメトリによって評価しながら探してみると次のような場合に起こることがわかった。まず成長温度を630℃以上にすることによって変化が生じることが確認できた。しかし完全に変化し終わるまでの時間は成長温度によって異なる。630℃では数十秒もかかり、また高温でのInP成長は難しいとの判断から650℃を選択することにした。650℃でInPの鏡面での成長を得るために成長条件を若干変更したのでその時のエリプソメトリのデータを図4に示す。また610℃成長時でもInGaAs成長後に過剰なAsを終端するためにIII族材料のみを導入することによっても実現できた(図5)。このように分光エリプソメトリによって様々な表面状態が測定できることがわかる。   この結果を元に井戸幅の非常に狭い単一量子井戸(SQW)を作製しPL測定からヘテロ界面の改善具合を評価した。評価結果を図6と図7に示す。図6は成長温度を610℃のままにしてIII族のみ導入状態を付加したもので、具体的なガス切り換えシーケンスは図6内に示した。図の横軸はIII族の供給時間から計算した井戸幅(1ML=0.2934nm)を、エラーバーは半値全幅(FWHM)を示す。全ての領域で以前のものよりもピーク波長が短波長側にシフトしている。発光波長の短波長化はInGaAs上のInP層へのAsの入り込みが減少したことを示唆しているので、界面急峻性が改善したと言える。また、図7には成長温度を650℃にした場合のSQWからの発光を調べた結果を示す。これも適切なガス切り換え時間を設定した結果としてPL発光波長が短波長側にシフトし、この方法によってもヘテロ界面の急峻性を改善させることができた。このようにMOVPE成長において分光エリプソメトリにより量子井戸作製時のガス切り換えシーケンスを改善できた。他にも分光エリプソメトリによる測定結果で、他の方法で測定された量子構造の特性が説明できる事柄を多く見いだした。  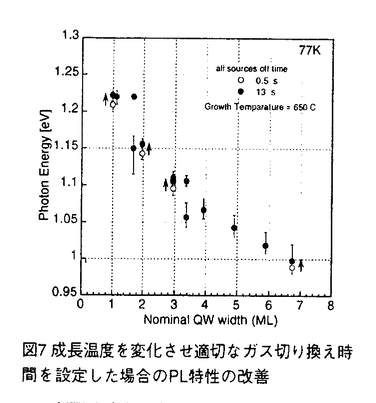 本研究では分光エリプソメトリを用いてMOVPE成長のその場観察を行い、成長中の試料からさまざまな有益な情報が得られることを示し、その結果を利用して実際に成長される量子構造の改善を行うことができることを示した。分光エリプソメトリ法は現在のMOVPE成長のその場観察手法として大いに期待できると言える。 | |
| 審査要旨 | 本論文は,半導体光・電子デバイス作製の中核プロセス技術である有機金属気相エピタキシャル成長(metal-orgarnic vapor phase epitaxy,MOVPE)に関し,特にInGaAsP/InP系材料のMOVPEにおける分光エリプソメトリを用いたその場観察法を研究し,組成および成長レートのリアルタイム測定や成長層表面状態のリアルタイム観察を可能にするとともに,その結果を応用して量子構造のヘテロ界面急峻性を格段に向上した結果をまとめたもので,6章より構成されている. 第1章は序論であって,研究の背景,動機,目的と,論文の構成を述べている.化合物半導体プロセス技術の中核であるエピタキシャル結晶成長の中で,制御性や量産性に優れるのはMOVPEであるが,ガスの流れや反応が絡んでくるため成長機構は一般に複雑である.成長条件は試行錯誤を繰り返さないと決めることができず,多大の労力と時間を要している.また,成長条件の装置依存性も大きく,上記の試行錯誤を装置毎にやり直す必要があって,効率が悪い.本論文は,MOVPE時の成長基板のその場観察を分光エリプソメトリ法を用いて行い,その結果を成長条件に反映させて,論理的に最適成長条件を決定する技術を確立せんとするものである.同時に,その観察結果を成長機構解明の一助とすることも目的としている. 第2章は「光学的手法による結晶成長のその場観察」と題し,各種の光学的その場観察法ならびに本論文で対象とする分光エリプソメトリ法の原理と,それらの利害得失について論じている.MOVPEは,分子線エピタキシーのような高真空中のプロセスではないので,その場観察のプローブとして電子線を用いることができず,光学的プローブを用いる必要がある.本研究で分光エリプソメトリを用いたのは,光学プローブの侵入長内の結晶成長層の組成(誘電率)の評価ができるためであったが,実際にはバルク状態の測定評価のみならず表面状態のその場観察にも適用できることが,本研究の結果分かっている.また従前の研究は,光学的手法を用いた結晶成長の機構解明に重点をおいたものが殆どであったが,本論文ではその場観察から得られる情報をフィードバックして,成長条件を最適化する(具体的には,ヘテロ界面の急峻性を確保する)ことに重きをおいている. 第3章は「MOVPE成長層の組成および成長レートの評価」と題し,結晶成長装置の実際,分光エリプソメトリの測定系,成長層の組成と成長レートをその場測定した結果について述べている.ここで用いたMOVPE装置は,分光エリプソメトリのための光学窓を持ち,また有機V族原料(TBP,TBA)を用いることを特徴としている.基板回転には水素ガスを用いており,エリプソメトリ測定中も回転させることができる.この点は,他の手法よりも回転起因の雑音に強いエリプソメトリの特長であると言える.分光エリプソメトリは位相変調型なので測定間隔を短くでき,ここでは最小0.2秒間隔で測定を行っている.次に,InGaAsP材料の誘電率の波長分散を,温度を変化させながら評価し,その結果を利用して成長レートのその場観察を行ったことについて論じている.さらに,成長レートが既知の場合に,現在成長中のInGaAsPの組成を誘電率のその場測定から推定する技術を研究している. 第4章は「InGaAsP系MOVPE成長層表面のその場観察」と題し,エピタキシャル成長層表面からの信号を,種々の環境条件のもとでその場測定した結果について論じている.エリプソメトリでは表面状態の観測は難しいという定説に対し,高感度かつ基板回転を行いながらの観測により,それが可能であることを明らかにしている.一方ここで扱うInPに格子整合したInGaAsP系混晶半導体では,ヘテロ界面でAsとPの置換が生じて,界面の急峻性を確保することが一般に難しい.これは次の成長層のV族原子が前に成長した層に侵入したり,前の層のV族原子が次の層に入り込むことによる.まず,成長温度610℃,成長圧力10kPaにおいて,InP表面からの信号をその場観察したところ,有機V族を導入した成長中断中に,そのV族を遮断すると信号の絶対値が変化すると同時に信号の振幅が変化した.これはInP表面のPもしくはTBPの分解生成物が脱離し,表面の異方性が変化したことに由来する.従って610℃では,充分速く表面の過剰なP(Pの分解生成物)は脱離することがわかった.しかしInGaAs表面からは,この成長条件において信号の変化はほとんど得られず,InGaAs表面から過剰なAs(TBAの分解生成物)がパージされない.この過剰なAsがInP/InGaAs/InPヘテロ界面を作製する際にInGaAs上のInP層中に入り込んで,ヘテロ界面の急峻性を劣化させることが示された.過剰なAsをパージするための手段としてInGaAs上にTBPを導入して表面のAs-P置換を引き起こすという選択肢も存在するが,これを行うとPが速やかにInGaAs層中へ拡散し,逆に界面急峻性の劣化を生じることが明らかになった.そこで,成長温度を650℃に上昇させてその場観察を行ったところ,過剰Asの脱離が短時間に進行したので,界面急峻性の改善に利用できることがわかった.一方,610℃成長時でもInGaAs成長後に過剰なAsを終端するためにIII族原料のみを導入することによっても,As過剰状態を回避できることが,その場観察によって確認された. 第5章は「量子構造成長時のガス切り替えシーケンスとエリプソメトリ信号の関係」と題し,前章の結果を元に井戸幅の非常に狭い単一量子井戸(SQW)を作製し,フォトルミネッセンス(PL)および透過電子顕微鏡測定からヘテロ界面の改善具合を評価した結果について論じている.III族の供給時間から計算した井戸幅を横軸に,PLピーク波長を縦軸にプロットすると,成長温度610℃でIII族のみ導入して過剰Asを終端した場合には,全ての井戸幅において従来よりもピーク波長が短波長側にシフトし,InGaAs上のInP層へのAsの取り込みが減少したことが示された.また,成長温度を650℃に上げた場合のSQWからの発光を同様に調べたところ,ピーク波長が短波長側にシフトし,この方法によってもヘテロ界面の急峻性を改善することのできることがわかった.このように,分光エリプソメトリその場観察により得られる情報から,量子構造作製時のガス切り換えシーケンスや成長温度を最適化できることが明らかになった. 第6章は結論であって,本研究で得られた成果を総括している. 以上のように本論文は,半導体光・電子デバイス作製の中核技術であるMOVPEにおいて,分光エリプソメトリを利用すれば従来難しかったその場観察を行うことができ,組成や成長レートをその場で決定できることを示すと同時に,従来不可能と思われていた表面状態の観測も基板を回転したままで行えることを明らかにして,その観測結果から成長条件を最適化し実際にInGaAs/InP量子構造のヘテロ界面急峻性を向上したものであって,電子工学分野へ貢献するところ少なくない. よって本論文は博士(工学)の学位請求論文として合格と認められる. | |
| UTokyo Repositoryリンク | http://hdl.handle.net/2261/1887 |