| 内容要旨 | | MOSFETの微細化に伴い,ゲート酸化膜界面特性を正確に評価をすることがますます重要になってきている.しかし従来の評価法ではゲート面積の縮小に伴い,測定精度を保つことが困難になってきている.さらに近年,高速・低消費電力素子として,実用化されつつあるSOI基板上のMOSFETにおける界面評価では,その素子構造の特殊性から従来の評価法を適用することが極めて難しい. Charge Pumping(CP)法はMOSFETの界面準位密度を電流値として直接的に求めることができる優れた界面評価法である.他の界面評価法と比べ,高精度な界面準位密度(平均値)の測定,界面準位密度のバンドギャップ内エネルギー分布,チャネル方向の分布を算出できるという特徴を有する.また,CP法はバルクMOSFFTはもちろん,SOI-MOSFETにおいても適用することができるため,今後の微細MOSFETの界面評価法として非常に有望である.しかし,CP法を微細バルクMOSFET及び薄膜SOI MOSFETに適用する際に生じるいくつかの特有の問題を明らかにしなくてはいけない.さらにこれらの問題を解決する手段が必要となる. 本研究では,従来のCP法より高周波での測定を可能とする新しい方法を提案し,微細バルクMOSFETのより広範囲の界面準位密度エネルギー分布を評価した.また,薄膜SOI MOSFETにおける最も大きな問題点である形状効果を抑制するために新しいReverse Pulse法を提案し,薄膜SOI MOSFETの界面準位のエネルギー及び横方向分布を正確に評価した. 1 徴細バルクMOSFETsにおける界面準位のエネルギー分布の測定法 MOSデバイスの界面準位密度のエネルギー分布を評価するための方法として,ゲートパルスの立上り及び立下り時間を変化させ測定可能エネルギー範囲を制御するtrf法が提案されている.しかし、微細MOSFETでは高精度を保つために,高周波CP測定が必要となる.その結果ゲートパルスの立上り及び立下り時間の可変範囲が強く制限されるので,従来のtrf法ではエネルギー範囲が制限される. そこで微細素子に適用できる新しい測定法(Reverse Pulse(RP)法)を提案した.図1に示すようにRP法ではtrとtfの代わりに,基板及びソース/ドレインに逆バイアスを印加することにより,ホール及び電子における偽フェルミ準位EFn,EFpを変化させ界面準位密度のエネルギー分布を求める.n-MOSFETを用いて測定した結果を図2に示す.tr,fを0.1 sから1 sから1 sまで変化させて測定した結果である. sまで変化させて測定した結果である. 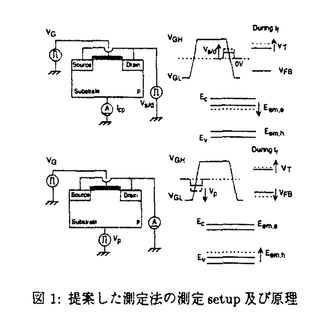 図1:提案した測定法の測定setup及び原理 図1:提案した測定法の測定setup及び原理 図2:tr,f法及びRP法における界面準位密度分布の測定結果.四角はtr,f法,丸いはRP法である.(tr,f法:Gate pulse tr,f=0.1 図2:tr,f法及びRP法における界面準位密度分布の測定結果.四角はtr,f法,丸いはRP法である.(tr,f法:Gate pulse tr,f=0.1 s〜1 s〜1 s,RP法:Gate pulse tr,f=0.1,0.4,1 s,RP法:Gate pulse tr,f=0.1,0.4,1 s,delay time td=0s.)L=5 s,delay time td=0s.)L=5 m,W=20 m,W=20 m. m. RP法による界面準位密度エネルギー分布の特性はtr,f法による測定結果とほぼ一致することが分かる.tr,f法に比べた時のRP法の利点を以下に挙げる. ・RP法では界面準位密度のエネルギー分布を測定するためにゲートパルス電圧の立上り・立下り時間を大きく変化させる必要がなく,微細化デバイスにおける高周波CP測定が可能. ・同じ立上り時間及び立下り時間を用いた場合,RP法の方が測定できるエネルギー輻が広い. ・SOI MOSFETのように形状効果が生じやすいMOSFETの測定では,RP法の方が精度がよい.また,RP法では形状効果を抑制できるので,立上り時間及び立下り時間大きく変化させることができ,その結果微細化デバイスにおける高周波CP測定が可能. 2 SOI MOSFETにおける形状効果及び解決方法 SOI MOSFETはバルクMOSFETと違ってチャネル直下のボディ領域の抵抗が極めて大きいため,n-MOSFETではホールによる形状効果が重要な問題となる. 形状効果を抑減するため,Body Contactに逆バイアスを印加するDC Reverse法が提案されている.SOI MOSFETに適用してみたことろ、図3のように,一定の逆バイアスをBody Contactに印加することによりホールのDrift速度が大きくなるので,確かに形状効果が減少した.しかし,BodyバイアスによりFront界面が蓄積状態になる時,ソース・ドレインの空乏層が広がり,実効チャネル長が短くなって,Icpが減少するので界面準位が正確に測定できない.Vbodyが-0.5Vより小さくなると実行チャネル長減少のためIcpはかなり減少している. そこで,実効チャネル長減少の影響を防ぎ,しかもホールによる形状成分をなくすため,我々はReverse Pulse Bias法を提案した.ホールによる形状成分が効いているのはパルスの立ち上がる瞬間のみである.従って,この瞬間だけ逆BodyバイアスVpを印加すればよい. 図3に,Reverse Pulse法適用時におけるIcpのVp依存性を示す.VbodyまたはVpが増加すると,形状効果が抑制されるので,Icpはともに減少する.しかし,一定逆バイアス印加時と違い,さらにVpを減少させても実効チャネル長の減少が生じないのでIcpが一定に落ち着くことが分かる.それにより、Reverse Pulse法では正確な界面準位測定が可能となる.なお,電子に対する形状効果が問題となるp-MOSFETの場合は,ゲートパルス立下り時のみにソースドレインに正のパルスを印加すればよい. 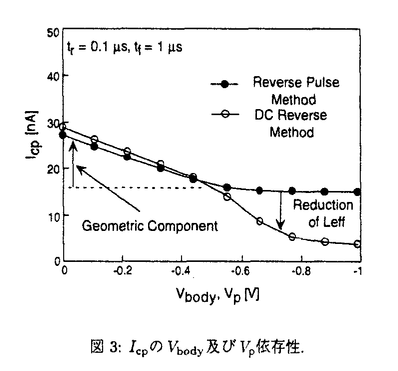 図3:IcpのVbody及びVp依存性. 図3:IcpのVbody及びVp依存性. 薄膜SOIデバイスにおいて我々が提案したReverse Pulse法では,CP法における最も重要な問題点である形状効果を抑制すると同時に実効チャネル長が変化しないので,界面準位を従来の方法より正確に測定できることを確認した. 3 SOI MOSFETにおける界面準位密度のエネルギー分布の評価方法 形状効果が生じやすい薄膜SOIデバイスでは,形状効果のみを抑制し界面準位密度のエネルギー分布を評価するため,我々は簡単かつ形状効果の抑制に有効なtr,f法及びRP法の組合せによる測定法を提案した. この測定法では,界面準位密度を測定するためtr,f法を用い,ホールによる形状効果が生じやすいtrの変化範囲に形状効果を抑制するためのbodyに逆パルス電圧を印加する.従来のtr,f法では図4のようにValence band edgeの領域では(trが小さい)形状成分によるDitが急激に増加し正確な界面準位密度が得られなかった.しかし,提案した測定法を用いることにより,形状効果をほとんど無くすことができる.  図4:tr,f法及び提案した測定法:界面準位密度エネルギー分布の測定結果.4 界面準位密度のチャネル方向分布 図4:tr,f法及び提案した測定法:界面準位密度エネルギー分布の測定結果.4 界面準位密度のチャネル方向分布 S/Dあるいはbodyコンタクトに逆バイアスを印加し,S/D近傍の空乏幅を変化させることで界面準位密度のチャネル方向分布を測定できる.ソース近傍の界面準位密度分布を評価するため,ドレインコンタクトをfloatingする.逆にドレイン近傍の面準位密度分布を評価するため,ソースコンタクトをfloatingし測定を行う. 従来のDC法では,tr,fが長い場合は正確に面準位密度を測定できた.しかし,tr,fが小さくなる(tr,f=0.1 s)と形状効果が顕著になり,界面準位に寄与しない形状成分が加わり見かけの界面準位密度が増加する(図6).微細薄膜SOIデバイスには高周波でのCP法を適応できなくなることが分かる. s)と形状効果が顕著になり,界面準位に寄与しない形状成分が加わり見かけの界面準位密度が増加する(図6).微細薄膜SOIデバイスには高周波でのCP法を適応できなくなることが分かる. 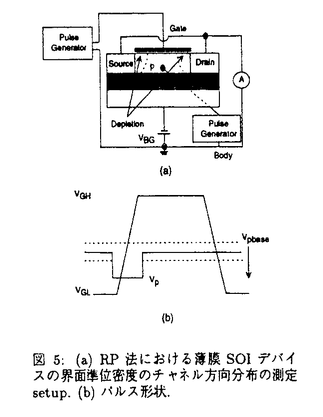 図5:(a)RP法における薄膜SOIデバイスの界面準位密度のチャネル方向分布の測定setup.(b)パルス形状. 図5:(a)RP法における薄膜SOIデバイスの界面準位密度のチャネル方向分布の測定setup.(b)パルス形状.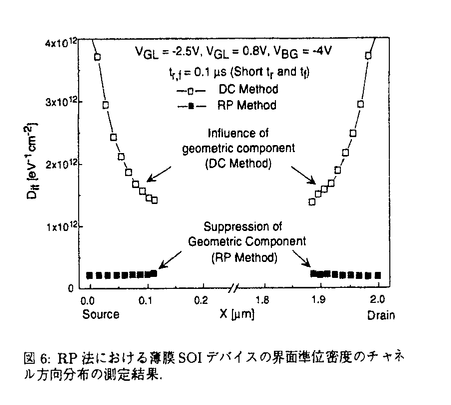 図6:RP法における薄膜SOIデバイスの界面準位密度のチャネル方向分布の測定結果. 図6:RP法における薄膜SOIデバイスの界面準位密度のチャネル方向分布の測定結果. そこで我々は形状効果抑制に有効なRP法を用いて,薄膜SOIデバイスの界面準位密度のチャネル方向分布を正確に測定する方法を提案した.測定系及びパルス形状を図5に示す.ゲートパルスの立上り時にbodyに一定の逆パルス(Vp)を印加し,形状効果を抑制できる.さらにゲートパルスの立上り以外でのVpbaseを変化させることでS/D近傍の空乏層幅を変化させる.提案した測定法で面準位密度のチャネル方向分布の測定結果を図6に示す.DC逆バイアス法では速い測定(tr,f=0.1 s)で形状効果により誤差が大きくなるが,我々が提案した新しい測定法ではtr,f=0.1 s)で形状効果により誤差が大きくなるが,我々が提案した新しい測定法ではtr,f=0.1 sでも正確な評価が得られた. sでも正確な評価が得られた. 5 おわりに 以上,本研究で新に開発した界面準位評価法およびこれらを用いて得られた微細MOSFET・薄膜SOI MOSFETの界面特性の測定結果を述べた.我々が提案した界面準位密度エネルギー分布の新しい評価法では,従来のtrf法に比べ立上り時間及び立下り時間大きく変化させることができるため,微細化デバイスにおける高周波CP測定を可能にする.それとともに,我々が開発した新しいReverse Pulse Bias法を用いることにより,CP法における最も大きな問題点である形状効果を抑制すると同時に実効チャネル長の変化を防ぎ,界面準位密度を従来の方法より正確に測定できることを確認した.形状効果を効果的に抑制できるReverse Pulse Bias法は,SOI MOSFETのように形状効果が生じやすいMOSFETの測定においてはより一層優位性を増す.さらにRP法の原理を元にした界面準位密度のチャネル方向分布の新しい測定法を開発し,従来のDC逆バイアス法より速い測定でも薄膜SOIデバイスの界面準位密度のチャネル方向分布の評価を可能にした. |
| 審査要旨 | | 本論文は,「Characterization of Interface States in Scaled Thin Film SOI and Bulk MOSFETs by Reverse Pulse Charge Pumping Technique」(和訳:逆バイアスパルスを用いたチャージポンピング法による微細薄膜SOI及びバルクMOSFETsの界面準位評価)と題し,英文で書かれている.本論文の目的は,従来正確な評価が困難であった微細MOSFETの界面準位測定について,逆バイアスを用いた新しいチャージポンピング法を提案し,その有用性を実験により実証することである.本論文は,新評価法が特に将来のデバイス技術として注目されているSOI(Silicon on Insulator)MOSFETに対して極めて有効であることを示すとともに,界面準位のエネルギー分布測定や空間分布測定にも適用可能であることを具体的に実証しており,全6章より構成される. 第1章は「Introduction」(序論)であり,従来のMOSFETにおける界面準位評価法を概説して,デバイスが微細になるに従い正確な評価が困難になることを示すとともに,チャージポンピング法による新手法の必要性を説き,本論文の目的を明確にしている. 第2章は「Charge Pumping:Principle and Experimental Setup」(チャージポンピング法の原理及び測定法法」と題し,感度の高い界面準位測定法であるチャージポンピング法の原理を説明し,その問題点である形状効果について言及している. 第3章は「Charge Pumping in Thin Film SOI MOSFETs」(薄膜SOI MOSFETにおけるチャージポンピング法)と題し,界面準位評価が従来極めて困難であったSOI MOSFETにおけるチャージポンピング法の問題点と解決法について述べている.完全空乏型のSOI MOSFETでは,ボディの抵抗が大きいため,チャネルが蓄積状態のときにゲート電界により誘起された多数キャリアが,チャネルが反転状態に切り替わっても,チャネルから即座に追い払われず,その結果少数キャリアと再結合して寄生的な再結合電流が測定されてしまう.このため,チャージポンピング電流が見かけ上増大し,界面準位密度を大きく見積もってしまうという問題がある.この形状効果を防ぐ方法として,本論文では,ゲート電圧の切り替え時にのみ,ボディに逆バイアスパルスを印加する方法を提案した.余分な多数キャリアは,この逆バイアスパルスによる電界のため即座にボディ端子に流入するので,寄生的な電流が発生せず,完全空乏型SOI MOSFETにおいても正確な界面準位密度の測定が可能となる.論文では,本逆バイアスパルス法の実験結果を詳細に解析し,本手法では副作用がなく,測定結果が定量的に正確であることを実験により実証している. 第4章は「Determination of Interface States in FD SOI MOSFETs」(完全空乏型SOI MOSFETの界面準位測定)と題し,SOI MOSFETにおける界面準位のエネルギー分布および空間分布測定に,本逆バイアスパルス法を応用する方法について述べている.従来,バルクMOSFETについては,界面準位のエネルギー分布および空間分布の測定法が広く知られているが,SOI MOSFETでは上記の形状効果のため,これらの適用は困難であった.本論文では,逆バイアスパルス法を用いれば形状効果が抑制され,SOI MOSFETにおいてもこれらの測定が可能であることを実験的に示している. 第5章は「Energy Distribution of Interface States in Scaled MOSFETs」(微細MOSFETにおける界面準位密度のエネルギー分布の測定法)と題し,本逆バイアスパルス法を界面密度のエネルギー分布測定に応用すると,従来のエネルギー分布測定より広いエネルギー範囲で測定が可能で,しかも従来法より微細なMOSFETにも適用可能であることを示している.従来のエネルギー分布測定は,ゲート電圧パルスの立ち上がりおよび立ち下がり時間を変化させて,関与する界面準位のエネルギーを変化させていたが,測定周波数が低くなるため感度が下がり,面積の小さな微細MOSFETには適用が困難であった.本手法では,立ち上がり時間等は最も速い時間に固定し,逆バイアスパルスの大きさを変化させて,関与する界面準位のエネルギーを変化させる.本手法で実際にエネルギー分布測定が可能であることを示し,従来法と比較を行い微細MOSFETでの有用性を実証している. 第6章は「Conclusions」(結論)であり,本論文の結論を総括している. 以上のように本論文は,従来困難であった微細MOSFET,特にSOI MOSFETにおける定量的な界面準位評価の問題点を指摘し,それを克服する逆バイアスパルスを用いた新しいチャージポンピング法を提案するとともに,本手法を界面準位のエネルギー分布測定や空間分布測定にも応用して,その有用性を実験的に実証したものであって,電子工学上寄与するところが少なくない. よって本論文は博士(工学)の学位請求論文として合格と認められる. |