学位論文要旨
| No | 114249 | |
| 著者(漢字) | 木村,康男 | |
| 著者(英字) | ||
| 著者(カナ) | キムラ,ヤスオ | |
| 標題(和) | 弾性応力下におけるアモルファスシリコンの結晶化過程に関する研究 | |
| 標題(洋) | ||
| 報告番号 | 114249 | |
| 報告番号 | 甲14249 | |
| 学位授与日 | 1999.03.29 | |
| 学位種別 | 課程博士 | |
| 学位種類 | 博士(工学) | |
| 学位記番号 | 博工第4375号 | |
| 研究科 | 工学系研究科 | |
| 専攻 | 電子工学専攻 | |
| 論文審査委員 | ||
| 内容要旨 | 多結晶シリコン(poly-Si)はCPU(Central Processing Unit)やメモリなどの半導体素子の中でMOSトランジスタのゲート電極や抵抗、配線材料として頻繁に使われる非常に重要な材料の1つである。また、EPROM(Erasable Programable Read Only Memory)やEEP-ROM(Electrically EPROM)、フラッシュメモリの浮遊電極としても用いられいる。さらに最近、液晶ディスプレイなどに欠かせないTFT(Thin Film Transistor)や薄膜太陽電池などの大面積基板としてpoly-Si薄膜を利用しようとする研究が盛んに行われている。また、微結晶シリコンによる単一電子トランジスタの研究の盛んに行われており、1998年に128Mbitの集積化に成功している[1]。そこで、本研究では最も一般的なpoly-Si膜の作製法の一つであるアモルファスシリコン(a-Si)を熱処理する方法をとりあげる。 一般的には結晶化は界面から始まると考えられているが[2]、清浄なa-Si薄膜表面が得られている場合には、表面から結晶化が始まるという報告もある[3,4]。さらに、水晶基板上のa-Si膜は表面から結晶化が始まるという研究結果が1997年に報告されている[5]。また、膜厚が1 本研究ではレーザラマン分光法によりpoly-Siの結晶性を評価し、基板として励起光(488nm)で透明な溶融石英基板を用いることにより表面側と界面側のa-Siの結晶化の様子を観察した。ただし、図1に示すように、溶融石英基板からのラマンスペクトルを除去するために励起光の偏光と垂直に偏光子を試料と分光器の間に入れた。結晶化率  さらに、結晶化過程に及ぼす歪みの効果を定量的に扱うために、a-Si膜上にSi3N4キャップをつけ、その膜厚を変化させることにより、a-Si膜に加わる応力を調整し、そのときの結晶化過程をレーザラマン分光法で観察した。Si3N4キャップの膜厚を変化させたときの結晶化過程の違いを図3に示す。結晶化率を見積もるときには先述の式を使い、散乱断面積の比 結晶化率を表す理論式として低結晶化率で成立するJohnson-Mehlの式 がある[7-10]。ここで、g,N,u,tは、それぞれ、結晶の形状因子(球のときは とすることで歪みの効果を導入した。ここで、 で与えられる。実験で求めた低結晶化率における結晶化率曲線から見積もったgNu3/4をこのモデルによる理論式でフィッティングした結果を図5に示す。このフィッティングにより求まったヘルムホルツの自由エネルギー差 結晶粒径もpoly-Siの物性を決める重要な要素であるが、それと歪みとの関係をX線回折法を用いて評価した。その結果を図6に示す。明らかにSi3N4の膜厚が厚くなりa-Si膜に加える応力が大きくなるにつれて結晶粒径が小さくなっていくことがわかる。この現象の機構は不明であるが、応力によって結晶粒径を変化させることができることを示した意味は大きいと考える。 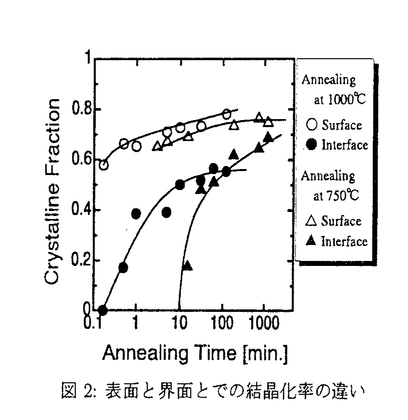      Oex5pt plus 2.5pt minus 1pt  . . . .        ," ,"   Й Й             ”" ”"      ≪ ≪           ≫,1976). ≫,1976). | |
| 審査要旨 | 本論文はラマン分光法を用いてアモルファスシリコンの結晶化過程に対する応力効果を調べたもので6章からなる。 第1章は序論であり、従来行われてきた研究をまとめ、本論文の背景、目的、意義を述べている。 第2章では、従来用いられているアモルファスからの結晶化の式(Johnson-Mehlの式)を発展させ、歪みの効果を取り入れた式を導いている。Johnson-Mehlの式には核形成頻度、核の成長速度などが入っているが、これ等には、アモルファスシリコンと結晶シリコンのヘルムホルツ自由エネルギーの差が取り入れられている。そこで、この項に歪みの効果を取り入れJohnson-Mehlの式を修正し新しい式を得ている。 第3章ではレーザーラマン法を用いて結晶化の程度を調べる原理について述べている。試料はアルゴンレーザに対して透明な溶液石英板を用い、この上に堆積したアモルファスシリコンを熱処理したものである。これに488nmの励起光をあて、ラマンスペクトルを測定する。今、結晶シリコンからのラマンピーク面積をIc,アモルファスシリコンからのラマンピーク面積をIaとすると、結晶率 第4章では、結晶化に及ぼす歪みの効果を調べている。応力が結晶化を遅くすることは第3章で明らかにした界面での結晶化が表面での結晶化よりも遅いことで示されているが、この章では歪みをより定量的に加えるためアモルファス層の上に厚さをいろいろ変化させたSi3N4膜を堆積している。結晶化率は前章で述べた さらに通常アモルファスの結晶化に用いている750℃という温度でSi3N4を堆積したシリコンを熱処理し、ラマンピークシフトにより歪みの変化を見ているが、殆ど変化がない事を発見している。このことから、アモルファスの結晶化に際し、歪みは殆ど変化していない事を結論づけている。即ち、応力存在下でのアモルファスシリコンの結晶化においては塑性変化は起こっておらず、弾性歪みの状況下で結晶化が進行していることを示している。これ等の実験結果を第2章で得た修正Johnson-Mehlの式を用いて解析した結果、界面自由エネルギーとして476[erg/cm2],アモルファスシリコンと結晶シリコンとのヘルムホルツ自由エネルギー差8.1kJ/molが得られた。この値は、文献値と比較的良い一致を示している。 第5章では応力と多結晶シリコン膜の粒子径の関係をX線解析および断面TEMを用いて調べている。この結果、応力が高い時には結晶粒の成長が抑えられること、その結果粒径の小さい結晶粒が多数できることを示している。 第6章は総括であり本研究の結果をまとめ今後の問題につき論じている。 以上これを要するに、本論文は、アモルファスシリコンの熱処理による結晶化過程とその応力依存性をラマン分光法を用いて調べ、結晶化開始位置、基板の結晶化に対する遅延効果およびSi3N4キャップ層による応力効果等を定量的に評価することにより、アモルファスシリコン結晶化のメカニズムを明らかにしたもので電子工学の発展に寄与するところが少なくない。 よって本論文は博士(工学)の学位請求論文として合格と認められる。 | |
| UTokyo Repositoryリンク | http://hdl.handle.net/2261/1891 |
 mのような厚い場合についてはほとんど研究されていない。このように、結晶化が膜のどこから始まるかなどといった基本的な事柄でさえよくわかっていないの現状である。さらに、結晶化に及ぼす応力の効果ということについてはほとんど研究されておらず全く解明されていない。ところが、実際の素子には大きな歪みが蓄積されており、ガラス基板上に堆積したa-Siにはさらに大きなストレスが蓄積されていることが予想される。このような応力がa-Siの結晶化過程にどのような効果を及ぼすのかを解明することは非常に重要なことである。
mのような厚い場合についてはほとんど研究されていない。このように、結晶化が膜のどこから始まるかなどといった基本的な事柄でさえよくわかっていないの現状である。さらに、結晶化に及ぼす応力の効果ということについてはほとんど研究されておらず全く解明されていない。ところが、実際の素子には大きな歪みが蓄積されており、ガラス基板上に堆積したa-Siにはさらに大きなストレスが蓄積されていることが予想される。このような応力がa-Siの結晶化過程にどのような効果を及ぼすのかを解明することは非常に重要なことである。 をラマンスペクトルから見積もるときには
をラマンスペクトルから見積もるときには Ia)を利用した。ただし、Ic,Iaはそれぞれ、結晶シリコン(c-Si)からのラマンピークのの面積とa-Siからのラマンピークの面積である。また、
Ia)を利用した。ただし、Ic,Iaはそれぞれ、結晶シリコン(c-Si)からのラマンピークのの面積とa-Siからのラマンピークの面積である。また、
 ),核生成頻度,核の成長速度,熱処理時間である。gNu3/4が大きいほど結晶化が速く進行するので、これは結晶化速度の指標となるパラメータである。Nとuにはa-Siとc-Siのヘルムホルツの自由エネルギー差
),核生成頻度,核の成長速度,熱処理時間である。gNu3/4が大きいほど結晶化が速く進行するので、これは結晶化速度の指標となるパラメータである。Nとuにはa-Siとc-Siのヘルムホルツの自由エネルギー差 がパラメータとなっているが、
がパラメータとなっているが、
 F0は無歪みにおけるヘルムホルツの自由エネルギーであり、
F0は無歪みにおけるヘルムホルツの自由エネルギーであり、 は歪み量
は歪み量 が緩和されないとしたときのc-Siとa-Siとの歪みエネルギーの差である。a-Si,c-Siの弾性定数をそれぞれKa-Si,Kc-Siとしたときには
が緩和されないとしたときのc-Siとa-Siとの歪みエネルギーの差である。a-Si,c-Siの弾性定数をそれぞれKa-Si,Kc-Siとしたときには
 は表1に示すように文献値とよい一致を示した。ただし、界面エネルギーの文献値は見つけることができなかったのでSi(111)と液体シリコンの表面エネルギーをそれぞれ示している。これらの表面エネルギーの差から界面エネルギーの桁を見積もることができる。この文献値との一致は、先に述べたモデルが妥当であることを示している。
は表1に示すように文献値とよい一致を示した。ただし、界面エネルギーの文献値は見つけることができなかったのでSi(111)と液体シリコンの表面エネルギーをそれぞれ示している。これらの表面エネルギーの差から界面エネルギーの桁を見積もることができる。この文献値との一致は、先に述べたモデルが妥当であることを示している。