| 内容要旨 | | 1.緒言 本研究の目的は,半導体デバイスなど固体材料の微小領域に適する新たな二次元・三次元定量分析法を開発することである。近年,電子素子はサブミクロンスケールにまで微細化・三次元化されている。また,各種クリーンプロセスに混入する異物粒子や大気汚染の一つである大気浮遊粒子状物質(suspended particulate matter,SPM)の発生起源や浮遊過程の解析にも,内部構造情報が大きな役割を果たすものと期待される。これらの分析には,空間分解能数10nm以下の三次元定量分析法が必要となる。微小領域の分析では,一次ビームに直径0.1 mまで収束可能なガリウム収束イオンビームを用いたGa FIB SIMSが開発され,shave-off法と呼ばれる微小粒子に対する一次元元素分布分析が可能となっている。従来の三次元分析では,深さスケーリングの際に測定中のエッチング速度を分析面内で一定と仮定している。しかしながら,イオンビームの入射角度と試料組成によってエッチング速度が違うため,深さスケーリングは事実上不可能と言える。任意の形状・組成分布を持つ試料の三次元分析が実現されていない理由は,主として深さスケーリングにあるが,イオン照射に伴う表面組成変化やスパッター物質の再付着,分析面の凹凸に起因した元素マッピングにおける定量性の低下も問題点として挙げられる。本研究では,Ga FIBを用いたshave-off走査による微細加工機能と電子ビーム(EB)による二次元オージェ分析機能を組み合わせることによって微小領域に適する新たな三次元定量分析法を提案し,イオン・電子デュアル収束ビーム装置を設計・試作し,サブミクロン空間分解能を有する新しい三次元定量分析法を開発した。また,EBを用いたオージェ電子分光法では,十分なS/N比を得るため積算時間が長く,導電性の低い試料においてはチャージアップによる分析条件が制限されることから,Ga FIB励起オージェ電子放出に関する基礎的な考察を行い,その特徴を活かして,サブミクロン面方向分解能を持つ二次元元素分析法を提案し,より短時間かつ高いコントラストでの元素マッピングを初めて実現した。 mまで収束可能なガリウム収束イオンビームを用いたGa FIB SIMSが開発され,shave-off法と呼ばれる微小粒子に対する一次元元素分布分析が可能となっている。従来の三次元分析では,深さスケーリングの際に測定中のエッチング速度を分析面内で一定と仮定している。しかしながら,イオンビームの入射角度と試料組成によってエッチング速度が違うため,深さスケーリングは事実上不可能と言える。任意の形状・組成分布を持つ試料の三次元分析が実現されていない理由は,主として深さスケーリングにあるが,イオン照射に伴う表面組成変化やスパッター物質の再付着,分析面の凹凸に起因した元素マッピングにおける定量性の低下も問題点として挙げられる。本研究では,Ga FIBを用いたshave-off走査による微細加工機能と電子ビーム(EB)による二次元オージェ分析機能を組み合わせることによって微小領域に適する新たな三次元定量分析法を提案し,イオン・電子デュアル収束ビーム装置を設計・試作し,サブミクロン空間分解能を有する新しい三次元定量分析法を開発した。また,EBを用いたオージェ電子分光法では,十分なS/N比を得るため積算時間が長く,導電性の低い試料においてはチャージアップによる分析条件が制限されることから,Ga FIB励起オージェ電子放出に関する基礎的な考察を行い,その特徴を活かして,サブミクロン面方向分解能を持つ二次元元素分析法を提案し,より短時間かつ高いコントラストでの元素マッピングを初めて実現した。 2.イオン・電子デュアル収束ビーム装置の設計と試作 三次元分析法の概念をFig.1に示す。まず,Ga FIBを断面加工専用として,shave-off走査で最初の断面を削り出す。次に,EBを用い,非破壊分析法であるSAM(scanning Auger microscopy)を断面の法線方向から断面に適用する。この二つ手法を繰り返すことによって,二次元オージェマップの蓄積という形で三次元元素マップを取得する。Shave-off走査では,断面がGa FIB入射方向とほぼ平行に削り出され,試料の形状と組成によらず,平滑な断面が得られる。従来の深さ方向分析で問題となる深さ(z方向)分解能の劣化に対して,本方法では直交三次元座標をオージェマッピング(x,y面内)と断面加工位置(z)によって決めることができる。又,Gaの注入に関して,イオンビーム照射に伴うイオン種の注入濃度は,表面法線からとった入射角度が大きいほど低い傾向がある。Shave-off走査は断面に対するGa FIBの入射角度が極めて大きい条件に相当するため,Gaの注入濃度が低く抑えられるものと考えられる。スパッター物質の再付着に関しては,Ga FIBは断面以外の箇所を再び照射することがないため,従来法よりも抑制されることが期待できる。この様な概念を基に,イオン・電子デュアル収束ビーム三次元分析装置を設計・試作した。装置の構成をFig.2に示す。特徴的なのは,試料に向ってGa FIBとEBを直交方向に配置した点である。三次元分析において,装置制御系にはGa FIBによる断面加工,Ga FIBのプランキング,EBとCMAを用いたオージェマッピングという一連の操作の繰り返し制御機能が必要である。このため,デュアルビーム制御系,信号検出・記録系のほとんどを専用に自作した。  Fig.1:三次元定量分析法の概念図 Fig.1:三次元定量分析法の概念図 Fig.2:イオン・電子デュアル収束ビーム装置の構成3.イオン・電子デュアル収束ビーム装置を用いた三次元分析 Fig.2:イオン・電子デュアル収束ビーム装置の構成3.イオン・電子デュアル収束ビーム装置を用いた三次元分析 Shave-off走査による分析断面加工効果を評価するため,SiO2粒子を用い,深さ分解能を大きく左右する加工断面の平滑性を実験的に検討し,平滑な断面が得られることが分かった。また,shave-off走査で加工したSi断面およびCu/Ni粒子断面に対してオージェ分析を行ない,Gaの注入汚染およびスパッター物質の再付着による断面組成の変化を抑制できることがわかった。 次に、実試料64Kbit EPROMを使って、三次元オージェ分析を行なった。分析はAl bonding wireとAl padとSi基板からなるbonding padのところを分析した。分析体積は70×70×50 mである。予めチャージアップを避けるため,IC表面に金蒸着した。Shave-off走査で断面を順次削り出し,各断面に対してEBオージェ分析によるAlとSiの二次元分析を行った。合計22時間で,128枚の二次電子像から32枚のAlとSiのオージェマップを抽出した。各オージェマップをz方向に並べて構築した三次元オージェマップをFig.3に示す。Si基板の上にAlパッド,そしてAlワイヤが乗っている様子が再現できた。また,Si基板は平板として現れるべきであるが,長時間測定のために,試料位置のドリフトが発生し,Z=30 mである。予めチャージアップを避けるため,IC表面に金蒸着した。Shave-off走査で断面を順次削り出し,各断面に対してEBオージェ分析によるAlとSiの二次元分析を行った。合計22時間で,128枚の二次電子像から32枚のAlとSiのオージェマップを抽出した。各オージェマップをz方向に並べて構築した三次元オージェマップをFig.3に示す。Si基板の上にAlパッド,そしてAlワイヤが乗っている様子が再現できた。また,Si基板は平板として現れるべきであるが,長時間測定のために,試料位置のドリフトが発生し,Z=30 m以降から少し湾曲している。試料ドリフトはソフト的に軸調整で解決した。現状では,分析体積は大きいものの,この結果から任意の形状と組成分布をもつ試料の三次元分析法を実現したといえる。 m以降から少し湾曲している。試料ドリフトはソフト的に軸調整で解決した。現状では,分析体積は大きいものの,この結果から任意の形状と組成分布をもつ試料の三次元分析法を実現したといえる。 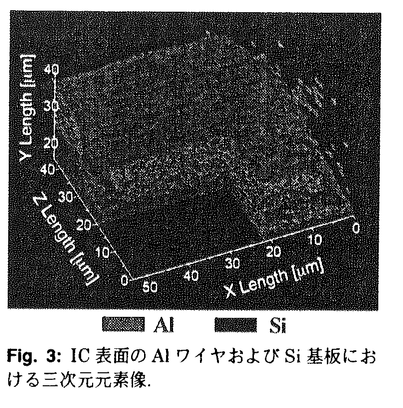 Fig.3:IC表面のAlワイヤおよびSi基板における三次元元素像.4.Ga FIB励起オージェ電子放出 Fig.3:IC表面のAlワイヤおよびSi基板における三次元元素像.4.Ga FIB励起オージェ電子放出 前節に示した三次元分析では,分析時間のうちオージェマッピングが11時間を占めた。そのため,長時間分析による試料ドリフトが起こってしまった。また,オージェ分析では,導電性の低い試料のチャージアップといった問題点に対して,試料傾斜,電荷補正など対策が行われているが,分析の自由度が制限されてしまう。ここで軽元素からなる固体試料からのGa FIB励起オージェ電子(Ga FIB LAE)放出の特徴を考察した。Fig.4にAlのGa FIB IAE及びEB励起オージェスペクトルを示す。IAEスペクトルには,62eV(I),56eV(II),48eV(III)に非常にシャープなatomic-likeピーク(AlLMM)が検出された。これらのatomic-likeピークは真空中にスパッターされた原子あるいはイオンから放出されたオージェ電子に対応する。メインAlLMMピーク(ピークI)のカウントレートがEB励起によるALLVVピークの二倍以上であり,signal-to-background(S/B)比が極めて高いことがわかった。このイオン励起オージェ電子を検出すれば,より短時間かつ高いコントラストで元素マッピングが可能であると考えている。さらにGa FIBの高収束性を加えることで,サブミクロン面方向分解能を持つ二次元元素分析が充分できると考えている。オージェ電子の収率は分析限界と感度を左右するため,Gaの入射エネルギー及びターゲット原子の種類によるIAE収率の関係を考察した。何れも入射イオンのエネルギーの増加に伴い直線的に増加することがわかった。  Fig.4:Al試料のGa FIB励起およびEB励起オージェ電子スペクトル。5.Ga FIB励起オージェ電子による二次元オージェマッピング Fig.4:Al試料のGa FIB励起およびEB励起オージェ電子スペクトル。5.Ga FIB励起オージェ電子による二次元オージェマッピング Ga FIB励起オージェ電子を用い,64Kbit EPROM表面上Al配線と基板のSiにおける元素マッピングを行った。IC表面のSiO2保護膜からSiLMMピークが検出されないため,FIBでそれを除去し、さらに基板のSiが露出するまで長時間スパッターした。メインAlLMM(Fig.4のピークI)とSiLMMオージェ電子によるマッピングを行い,初めてAl,Siの二次元元素分析を実現した。AlLMMとSiLMM像をFig.5に示す。一元素マップが10分間で得られた。面方向分解能が0.6 mで,Alの最大カウント数は4000以上,Siでは2000以上に達した。黒い部分のカウント数をノイズレベルとすると,ノイズが30カウントとなる。実験に300pAのビーム電流を用いたが,このS/N比から,10分の1のビーム電流でも十分マッピングできると考えられる。電流が少ないほどビームを細く絞れるので,面方向分解能の向上を期待できる。また,イオン励起オージェ電子放出は激しい原子衝突が前提で,EB励起オージェ電子放出と異なり,その励起範囲がビームのスポットサイズとほぼ一致すると考えられる。現在、10nmまで収束可能なFIBが既に商品化されており,Ga FIB IAEによる10nmレベルの面方向分解能でのマッピングが可能である。そして,SiO2からオージェ電子が検出されないことから,IAEマップから化学的な情報が得られると考えられる。 mで,Alの最大カウント数は4000以上,Siでは2000以上に達した。黒い部分のカウント数をノイズレベルとすると,ノイズが30カウントとなる。実験に300pAのビーム電流を用いたが,このS/N比から,10分の1のビーム電流でも十分マッピングできると考えられる。電流が少ないほどビームを細く絞れるので,面方向分解能の向上を期待できる。また,イオン励起オージェ電子放出は激しい原子衝突が前提で,EB励起オージェ電子放出と異なり,その励起範囲がビームのスポットサイズとほぼ一致すると考えられる。現在、10nmまで収束可能なFIBが既に商品化されており,Ga FIB IAEによる10nmレベルの面方向分解能でのマッピングが可能である。そして,SiO2からオージェ電子が検出されないことから,IAEマップから化学的な情報が得られると考えられる。  Fig.5:Ga FIB IAEによるIC表面のAlLMM(A)およびSiLMM(B)像.6.結論 Fig.5:Ga FIB IAEによるIC表面のAlLMM(A)およびSiLMM(B)像.6.結論 本研究では,大きさ数ミクロンの任意の形状をもち,または不均一な組成の試料に適用できる新しい三次元分析法を開発するため、イオン・電子デュアル収束ビーム装置を設計・試作した.そしてイオンビームによる断面加工において,断面の平滑性,一次イオンの注入汚染,スパッター物質の再付着,偏析に関する基礎的な考察をし,三次元オージェ分析にshave-off走査およびEBによる二次元オージェ分析を組み合わせることによって,サブミクロン空間分解能を有する新しい定量分析法を確立した。また,Ga FIB励起オージェ電子放出の特徴を活かし,サブミクロン面方向分解能を持つ新たな元素分析法を検討し,より短時間かつ高いコントラストでの元素マッピングを実現した。 |
| 審査要旨 | | 本論文は、イオン・電子デュアル収束ビームを用いた固体試料の三次元マイクロアナリシスに関する研究と題し、6章よりなる。 第1章は序論であり、本研究の背景並びに目的、関連する分野の概要、本論文の枠組みに関してまとめている。近年、電子素子はサブミクロンスケールにまで微細化・三次元化されている。また、各種クリーンプロセスに混入する異物粒子や大気汚染の一つである大気浮遊粒子状物質(SPM)の発生起源や浮遊過程の解析にも、内部構造情報が大きな役割を果たすものと考えられている。これらの分析には、空間分解能数10nm以下の三次元定量分析法が必要となる。従来、任意の形状・組成分布を持つ試料の三次元分析が実現されていない理由は、主として深さスケーリングにあるが、イオン照射に伴う表面組成変化やスパッター物質の再付着、分析面の凹凸に起因した元素マッピングにおける定量性の低下も問題点として挙げられる。本研究では、ガリウム収束イオンビーム(Ga FIB)を用いたshave-off走査による微細加工機能と電子ビーム(EB)による二次元オージェ分析機能を組み合わせることによって微小領域に適する新たな三次元定量分析法を提案し、イオン・電子デュアル収束ビーム装置を設計・試作し、サブミクロン空間分解能を有する新しい三次元定量分析法を開発した。 第2章は、イオン・電子デュアル収束ビーム装置の設計と試作について述べている。まず、Ga FIBを断面加工専用として、断面に対し速い水平方向走査と極めて遅い垂直方向走査とを組合せたshave-off走査で最初の断面を削り出す。次に、電子ビームを用い、非破壊分析法である走査型オージェ電子顕微鏡(SAM)を断面の元素分布測定に適用する。この二つ手法を繰り返すことによって三次元元素マップを取得する。Shave-off走査では、断面がGa FIB入射方向とほぼ平行に削り出され、試料の形状と組成によらず、平滑な断面が得られる。従来の深さ方向分析で問題となる深さ(z方向)分解能の劣化に対して、本方法では直交三次元座標をオージェマッピング(x,y面内)と断面加工位置(z)によって決めることができる。Shave-off走査は断面に対するGa FIBの入射角度が極めて大きい条件に相当するため、Gaの注入濃度が低く抑えられる。スパッター物質の再付着に関しては、Ga FIBは断面以外の箇所を再び照射することがないため、従来法よりも抑制される。この様な概念を基に、イオン・電子デュアル収束ビーム三次元分析装置を設計・試作した。特徴的なのは、試料に向ってGa FIBと電子ビームを直交方向に配置した点である。 第3章では、イオン・電子デュアル収束ビーム装置を用いた三次元分析について述べている。まず、Shave-off走査による分析断面加工効果を評価するため、SiO2粒子を用い、深さ分解能を大きく左右する加工断面の平滑性を実験的に検討し、平滑な断面が得られる条件を明らかにした。また、shave-off走査で加工したSi断面およびCu/Ni粒子断面に対してオージェ分析を行ない、Gaの注入汚染およびスパッター物質の再付着による断面組成の変化を抑制できることを示した。次に、実試料を使って、三次元オージェ分析を行なった。EPROMのAl bonding pad部分を三次元分析した。 第4章では、ガリウム収束イオンビーム(Ga FIB)励起によるオージェ電子放出について述べている。前節に示した三次元分析では、分析時間のうちオージェマッピングに長時間を要するという問題点を有している。そこで軽元素からなる固体試料からのGa FIB励起オージェ電子放出の特徴を考察した。アルミニウム試料からのスペクトルには、非常にシャープなatomic-likeピーク(AlLMM)が検出された。これらのatomic-likeピークは真空中にスパッターされた原子あるいはイオンから放出されたオージェ電子に対応すると考えられる。主ピークの感度は電子ビーム励起によるAlLVVピークの二倍以上であり、信号バックグランド比が極めて高いことがわかった。このイオン励起オージェ電子を検出すれば、より短時間かつ高いコントラストで元素マッピングが可能である。さらにGa FIBの高収束性を加えることで、サブミクロン面方向分解能を持つ二次元元素分析が実現できると考えられる。オージェ電子の収率は分析限界と感度を左右するため、Gaの入射エネルギー及びターゲット原子の種類による収率の関係も考察している。 第5章では、ガリウム収束イオンビーム(Ga FIB)励起オージェ電子による二次元オージェマッピングについて述べている。Ga FIB励起オージェ電子を用いIC表面に対して、AlLMMとSiLMMオージェ電子によるマッピングを行い、世界に先駆けてイオン励起オージェ電子による二次元元素分析を実現した。得られた分布像の面方向分解能が0.6 mであったが、S/N比を考慮すれば、10分の1のビーム電流でも十分マッピングできると考えられる。また、イオン励起オージェ電子放出は、その励起範囲がビームのスポットサイズとほぼ一致すると考えられる。現在、10nmまで収束可能なFIBが既に開発されており、10nmレベルの面方向分解能でのマッピングが可能である。 mであったが、S/N比を考慮すれば、10分の1のビーム電流でも十分マッピングできると考えられる。また、イオン励起オージェ電子放出は、その励起範囲がビームのスポットサイズとほぼ一致すると考えられる。現在、10nmまで収束可能なFIBが既に開発されており、10nmレベルの面方向分解能でのマッピングが可能である。 第6章においては結論が述べられている。本研究では、大きさ数ミクロンの任意の形状をもち、または不均一な組成の試料に適用できる新しい三次元分析法を開発する目的で、新たにイオン・電子デュアル収束ビーム装置を設計・試作している.そしてイオンビームによる断面加工において、断面の平滑性、一次イオンの注入汚染、スパッター物質の再付着、偏析に関する基礎的な考察をし、三次元オージェ分析にshave-off走査および電子ビームによる二次元オージェ分析を組み合わせることによって、サブミクロン空間分解能を有する新しい定量分析法を確立した。また、Ga FIB励起オージェ電子放出の特徴を活かし、サブミクロン面方向分解能を持つ新たな元素分析法を検討し、より短時間かつ高いコントラストでの元素マッピングを実現した。 以上本論文は新しいアイデアを基に新規性の高い装置を設計・製作し、固体の三次元分析を実現すると共に、そこで得られた新しい現象を利用した分析法確立のための基礎的検討を行ったものであり、物質情報工学ならびに工業分析化学に対して貢献するところが大きい。よって、本論文は博士(工学)の学位請求論文として合格と認められる。 |