| 内容要旨 | | 近年LSIの低消費電力化の必要性が高まっている.CMOS低消費電力化の手法として,消費電力に2乗で効く電源電圧の低減が最も有効である.しかし電源電圧を下げるとゲートドライブVdd-Vthが減少するため駆動力が低下してしまう.但しVddは電源電圧,Vthはしきい電圧である.駆動力低下を回避するためにはVthも下げる必要があるが,Vthを下げるとサブスレッショルド電流によるリーク電流が桁で増大し,スタティック消費電力が増大する.従って低電源電圧で高性能(高速)を実現するために,オフ電流の低減とオン電流の増大が同時に実現可能なデバイスの開発が強く求められている. 0.5V以下の超低電源電圧において低オフ電流と高オン電流を両立する優れたMOSFETとしてdynamic threshold MOSFET(DTMOS)がある.DTMOSとはMOSFETのゲートとボディを配線で結んだデバイスである.表1にDTMOSの特徴を示す.  表1:DTMOSの特徴 表1:DTMOSの特徴 DTMOSは表面電位とゲート電位が常に等しいためS値が理想値60mV/decを示す上に,Vthがゲート電圧に応じて変化するため非常に高いオン電流/オフ電流比が実現可能である.図1にDTMOSのゲート特性を通常MOSFETと比較して示す.DTMOSではVgsを上げるとボディ電位が正にバイアスされるために基板バイアス効果によりVthが Vthだけ低下し駆動力が高まる.この結果,通常MOSFETのゲートドライブがVdd-Vthであるのに対し,DTMOSのゲートドライブはVdd-(Vth- Vthだけ低下し駆動力が高まる.この結果,通常MOSFETのゲートドライブがVdd-Vthであるのに対し,DTMOSのゲートドライブはVdd-(Vth- Vth)に増大する. Vth)に増大する. Vthは Vthは Vddに等しい. Vddに等しい. は基板バイアス係数である.従ってDTMOSの高駆動力化の指針は,基板バイアス効果を増大させ は基板バイアス係数である.従ってDTMOSの高駆動力化の指針は,基板バイアス効果を増大させ Vthを大きくすることである.ところが従来のDTMOSではチャネル濃度がVthと Vthを大きくすることである.ところが従来のDTMOSではチャネル濃度がVthと を同時に決定するため. を同時に決定するため. が0.2-0.3程度と小さくDTMOS固有の高駆動力の利点を生かし切れていなかった. が0.2-0.3程度と小さくDTMOS固有の高駆動力の利点を生かし切れていなかった.  図1:DTMOSと通常MOSFETのゲート特性 図1:DTMOSと通常MOSFETのゲート特性 そこで図2に本研究で提案するElectrically Induced Body DTMOS(EIB-DTMOS)のCMOSデバイス構造を示す.ボディは埋め込み酸化膜下の基板(バックゲート)にスタティックなバイアスをかけることによりSOI中のバック界面に電気的に誘起する.電気的に誘起されたボディ(EIB)により,通常の不純物ドーピングでは実現不可能な非常に急峻なステップ形状のチャネルプロファイルが形成される.ゲートとEIBをボディコンタクト経由で結ぶことによりDTMOSとして動作させる.チャネルのドーパントにより,図2(a)に示すインバージョンモードEIB-DTMOSと図2(b)に示すアキュミュレーションモードEIB-DTMOSがある.インバージョンモードEIB-DTMOSの場合,表面チャネルのキャリアは反転により誘起され,アキュミュレーションモードEIB-DTMOSの場合,表面チャネルのキャリアは蓄積により誘起される.両者共にVthは正(nMOSの場合)である.アキュミュレーションモードEIB-DTMOSのEIBを構成するホール(nMOSの場合)はp+ボディコンタクト領域から供給される. 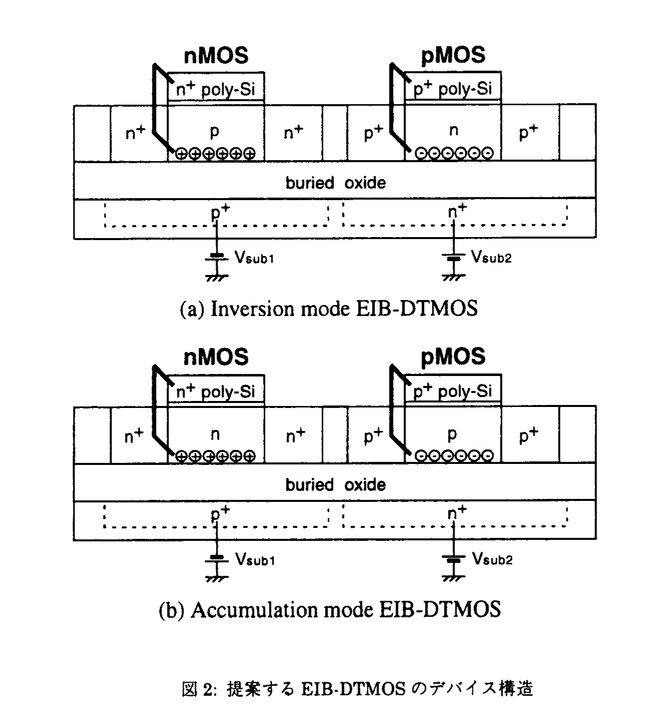 図2:提案するEIB-DTMOSのデバイス構造 図2:提案するEIB-DTMOSのデバイス構造 EIB-DTMOSのプロセス可能性について述べる.バックゲートのレイアウトはbulkCMOSにおけるウェルと全く同様に多数のMOSFETで1つのバックゲートを共有する.但し極性の異なるバックゲート間距離は逆接合耐圧を考慮し広げる必要がある.CMOSの場合,埋め込み酸化膜下のバックゲートの極性を変える必要があるが,埋め込み酸化膜越しのイオン注入により作成可能である.またバックゲートへのコンタクトはSTI,埋め込み酸化膜を貫通して取る.基板バイアスは外部供給,内部生成いずれでもよい. 提案したEIB-DTMOSと従来型DTMOSの基板バイアス係数を定性的に比較する.図3に従来型DTMOSとEIB-DTMOSの基板バイアス係数( )の決まる原理と式を示す. )の決まる原理と式を示す.  図3:従来型DTMOSとEIB-DTMOSの基板バイアス係数( 図3:従来型DTMOSとEIB-DTMOSの基板バイアス係数( ) ) Cfoxはゲート酸化膜容量,CDはチャネル空乏層容量,CSOIはSOI容量,tfoxはゲート酸化膜厚,lDはチャネル空乏層幅,tSOIはSOI膜厚,NAはチャネル濃度を示す.従来型DTMOSでは均一チャネルプロファイルを仮定した.従来型DTMOSでチャネル空乏層幅はチャネル濃度で決まるため, を大きくするためにはチャネル濃度を上げる必要がある.しかし従来型DTMOSではVthを0.3V程度に設定しているためチャネル濃度は低く抑えられ, を大きくするためにはチャネル濃度を上げる必要がある.しかし従来型DTMOSではVthを0.3V程度に設定しているためチャネル濃度は低く抑えられ, は0.2-0.3と低い.一方EIB-DTMOSではチャネル空乏層幅がSOI膜厚と等しいため,SOIを薄膜化することにより は0.2-0.3と低い.一方EIB-DTMOSではチャネル空乏層幅がSOI膜厚と等しいため,SOIを薄膜化することにより を大きくすることが出来る.またEIB-DTMOSをアキュミュレーションモードで動作させれば高 を大きくすることが出来る.またEIB-DTMOSをアキュミュレーションモードで動作させれば高 と低Vthを両立できる.従って と低Vthを両立できる.従って の大きいEIB-DTMOSは従来型DTMOSより高駆動力が得られる.チャネル空乏層幅の縮小は短チャネル効果抑制作用もある. の大きいEIB-DTMOSは従来型DTMOSより高駆動力が得られる.チャネル空乏層幅の縮小は短チャネル効果抑制作用もある. EIB-DTMOSのメリットを実証するために,インバージョンモードEIB-DTMOSを完全空乏型SOI MOSFET,部分空乏型SOI MOSFETと実測で比較した.その結果,EIB-DTMOSは急峻なサブスレッショルド特性を有し,短チャネル効果を最も抑制するため,高駆動力かつ低リーク電流を実現していることがわかった.これに対し,部分空乏型SOI MOSFETは低駆動力であり完全空乏型SOI MOSFETはリーク電流が大きかった. また,これまでに提案されているDTMOSとEIB-DTMOSをデバイスシミュレーションにより比較した.その結果,アキュミュレーションモードEIB-DTMOSはVthシフトが最大かつ短チャネル効果を抑制するなめ,一定オフ電流で駆動力が最大であり,最も優れたDTMOSであることを示した.従ってアキュミュレーションモードEIB-DTMOSは0.5V以下での超低電源電圧において高駆動力と低リーク電流を両立する高性能MOSFETである. |
| 審査要旨 | | 本論文は,「High Performance SOI MOSFET Device Design at Very Low-Voltage for Low-Power VLSI」(和訳:低電力VLSI用低電圧SOI MOSFETの高性能化に関する研究)と題し,英文で書かれている.本論文の目的は,電源電圧1V未満という低電圧において動作するVLSI用に,高性能なデバイス設計の指針を示すことである.本論文は,特に基板バイアス効果を利用してしきい値電圧を制御するデバイス構造に注目し,基板バイアス定数とデバイス性能の関係を議論するとともに,基板バイアス定数が極めて大きくなりうる新規デバイスを提案・実証しており,全6章より構成される. 第1章は「Introduction」(序論)であり,VLSI用のMOSFETのトレンドをレビューするとともに,低消費電力・低電力デバイスの重要性について概説し,本論文の目的を明確にしている. 第2章は「Features of DTMOS」(DTMOSの特徴)と題し,ゲート電極とボディ領域を接続ししきい値電圧をダイナミックに制御するDynamic Threshold MOS(DTMOS)について概説している.DTMOSは本論文における低電圧動作MOSFETの基本デバイスであり,その動作原理と利点,課題を著者なりの考えでまとめることにより,本論文の問題意識を提起している. 第3章は「Different Dependence on Body Effect Factor in DTMOS and Conventional MOSFET」(DTMOSと従来MOSFETにおける基板バイアス定数依存性の差)と題し,基板バイアス定数とMOSFETの駆動力との関係について述べている.まず,さまざまなMOSFETの構造をバックゲート構造とバックバイアス印加法により分類した.次に,バックバイアスが固定されているMOSFET構造において,基板バイアス定数と各種デバイス性能(サブスレッショルド係数,短チャネル効果,駆動力等)との関係をシミュレーション結果を通じて議論し,バックバイアス固定デバイスでは低電圧において高駆動力と低リーク電流を両立させることが困難であることを示した.また,バックバイアスが可変のDTMOSでは,基板バイアス定数が大きくなるほど電流駆動力が大きくなることをシミュレーションにより示した. 第4章は「DTMOS Performance Enhancement by Large Body Effect」(基板バイアス効果増大によるDTMOSの性能向上)と題し,レイアウト面積一定という条件下でDTMOSと基板バイアス定数の関係について論じている.DTMOSは,ゲートとボディを接続するために余分の面積を必要とするが,これまでエリアペナルティを考慮したDTMOSの議論は行われていなかった.従来MOSFETとDTMOSの性能を比較した結果,DTMOSのエリアペナルティを考慮してもDTMOSの方が駆動力が高いことを示した,一方,基板バイアス定数を極めて大きくする方法として,SOI基板に定電圧を印加しバック界面にキャリアを誘起させる方法(EIB)を提案し,しかもアキュミュレーションモードのMOSFETにおいてはしきい値電圧を低く抑えたまま大きな基板バイアス定数を実現できることを明らかにした. 第5章は「EIB-DTMOS with Large Body Effect」(基板バイアス定数の極めて大きなEIB-DTMOS)と題し,基板バイアス定数の極めて大きなDTMOS構造を提案し,その性能を実験とシミュレーションにより実証している,基板バイアス定数を極めて大きくする方法としては前述のEIB構造を用い,実際にデバイスを試作してデバイス性能の比較を行った.その結果,完全空乏型および部分空乏型SOIデバイスと比較して,EIB-DTMOSは極めて低いオフ電流において大きな駆動力が得られることを示した.一方,各種DTMOS構造の性能をシミュレーションにより比較することにより,アキュムレーションモードのEIB-DTMOSが最も高性能であることを明らかにした. 第6章は「Summary and Conclusions」(結論)であり,本論文の結論を総括している. 以上のように本論文は,低電圧動作MOSFETの高性能化において基板バイアス定数が重要なパラメータであることを見出し,しきい値電圧制御デバイスにおいては基板バイアス定数が大きいほど駆動力が増大することを明らかにするとともに,SOI基板に電圧を印加することによりバック界面にキャリアを誘起させ高基板バイアス定数を実現できるデバイス構造を新たに提案して,実験およびシミュレーションによりその有用性を実証したものであって,電子工学上寄与するところが少なくない. よって本論文は博士(工学)の学位請求論文として合格と認められる. |