現代の電子工学の発展には目ざましいものがある。材料開発は工学の基礎であるが、電子工学においても新しい電子機能材料の開発はその基礎となるものである。企業での材料開発においては、高品質なものを経済的に作製することが大きな課題である。一方、近年の計算機技術の進歩は素晴らしく、この様な課題に対し工学の様々な分野で数値解析技術が活用されているが、材料開発分野では一歩遅れているのが現状である。特に材料開発の下工程である作製プロセスは、生産現場と直結しているため企業での重要性は大きいものの、現象の主な支配方程式であり流体プロセスの状態を記述するナビエ・ストークス方程式が強い非線型性を有していること、複雑な現象のモデル化に困難を伴なうこと等のため、企業で実効に結びつく実用レベルの解析は大変に少なく成功例が限られた状態であった。筆者は、オプトエレクトロニクスに関する代表的な新素材であるGaAsをはじめとした化合物半導体と光ファイバの作製プロセスについて、高品質材料の経済的作製に資するため、主として熱・流体解析技術の研究を行なった。本研究は材料開発に関し数値解析の適用が非常に少なかった1980年頃から始め、企業での実用レベルの適用までもっていったものである。主要な研究内容と成果は以下のとおりである。 (1)高品質化合物半導体の経済的作製に資するプロセス解析技術の研究 化合物半導体の代表格であるGaAsは、Siに比べ5〜6倍の電子移動度を持つ等の長所があるが、材料の欠陥が問題、高価等の短所がある。そこで主要なプロセスであるバルク単結晶およびエピタキシャル薄膜結晶作製プロセスにつき、高品質結晶を安価に製造しうる事を狙い、数値解析技術の研究を行なった。 (1)LEC法によるバルク単結晶作製は大口径化が容易、成長速度も速い等経済的利点がある。しかしAs抜けを防ぐため結晶固液界面をB2O3で封止するが、この断熱効果による大きな温度勾配に起因する熱応力により結晶欠陥が増すため、炉内の温度分布の予測と制御が重要である。現象は高温、高圧炉内の熱対流、熱輻射を伴なったものであるため、実炉の温測や数値解析は困難なものであった。 主として解析モデルにより炉内の熱輸送の切り分けを行なったところ、伝導と対流は基本の熱輸送方程式を忠実に解けばかなり信頼のおける温度分布が得られるのに対し、輻射は輻射能をうまく推定して解くことが重要であることが分かった。すなわち図1に示す如く、るつぼ付近の上昇流による冷却効果は現実的な引き上げ条件の変化に対し変動が小さいが、ヒータ輻射による昇温効果は輻射能により変動している。そこで複雑な形状の実用炉に関し、ナビエ・ストークス方程式を含む熱輸送方程式を精度よく効率的に解く方法、および実測と計算等により輻射能の推定とモデル化の方法とを検討し開発した所、図2に示す如く固液界面付近で計算値と実測値は数十度以下、誤差として数パーセント以下の精度で一致する数値解析技術を開発し得るに至った。  図表図1 るつぼ近傍の輻射および対流の効果評価 / 図2 固液界面付近の中心軸上温度分布(計算値と実測値的比較) 図表図1 るつぼ近傍の輻射および対流の効果評価 / 図2 固液界面付近の中心軸上温度分布(計算値と実測値的比較) 本技術により1983年には自動直径制御技術を確立し、それまでが2インチ主流であったのに対し3インチ結晶を安定に得ることが出来た。1985年には熱流解析を駆使し、転位密度が102cm-2以下の「無転位」状態がウェハ面積の40%を占める高品質結晶の開発に成功した。すなわち、るつぼ上部空間を2分割すれば、結晶を急冷していたその空間の大きな自然対流を抑え込み結晶近傍の温度環境を改善しうることを熱流解析で予測し、実際に炉を改造してその効果を確認するに至った。図3に熱環境の改善解析を図4に結晶応力の改善解析を示す。さらに現在は4インチ結晶の高品質化、低コスト化、6インチ結晶の開発に向け本技術が活用されている。  図表図3 LEC法における熱環境の計算機解析 / 図4 ホットゾーン改良による結晶応力の変化 図表図3 LEC法における熱環境の計算機解析 / 図4 ホットゾーン改良による結晶応力の変化 (2)縦型クロライドVPE法によるエピタキシャル薄膜結晶作製は歴史ある方法であり、大口径化、多数枚チャージが容易等量産性に長所がある。しかし結晶の均一性に問題があった。VPEプロセスは原料ガスを高速で基板部へ輸送し、そこで化学反応により薄膜を形成するものである。したがって良質の高均一大口径エピウェハーを開発するには炉内のガス流状態、温度、反応種分圧の把握が基本である。しかしこれまでの企業の現場においてはこの問題への対応は十分でなく、経験と勘に多くを頼っていた状態であり、特に経済性を目指した炉の大型化に際しこの理論的な把握、検討が不可欠となった。炉内の熱流状態に関しては前記のバルク単結晶作製に用いた熱流解析法を援用した所、図5に示す如く熱流に伴なう炉内温度分布を実測ともよく対応して解析し得ることが分った。反応種分圧や結晶成長反応に関しては、系は近似的に熱平衡状態であると考え熱力学計算を行なった所、温度、流量のプロセス条件変化に対応し結晶成長速度を実測ともよく対応して説明し得ることが分かった。図6はその結果を示すが、自然対流効果を考慮した熱力学計算(K=Variableのもの)によれば広い温度領域にわたって事実をよく説明し得ている。またVPEプロセスは低温領域では化学反応律速といわれているが、我々の対象である多数枚チャージの大型炉では大量のキャリアガスを導入し希釈して流すため、広い温度領域で物質輸送律速として実用的にプロセスを説明し得た。 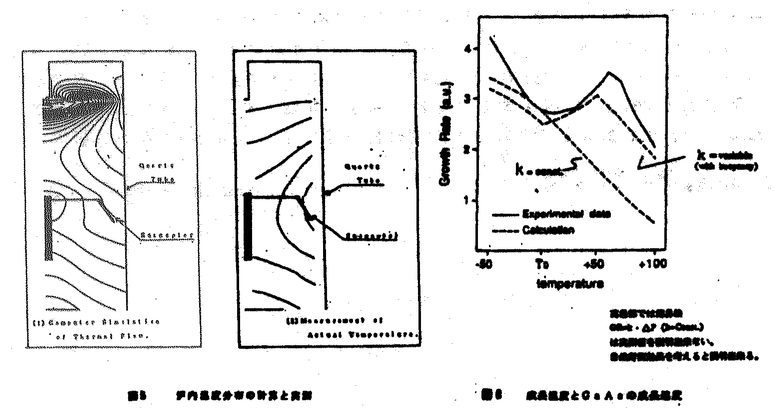 図表図5 炉内温度分布の計算と実測 / 図6 成長温度とGaAsの成長温度 図表図5 炉内温度分布の計算と実測 / 図6 成長温度とGaAsの成長温度 本技術によりプロセスの事前予測が可能となり、1986年には大型反応管を新たに設計、開発して3インチ径の面内均一性3%以内という大口径、高均一エピウェハーを安定に生産するに至った。その均一性データを図7に、表面状態を写真1に示す。  図表図7 安定生産された高均一GaAsエピウェハー / 写真1.従来ウェハー(左)と3インチ高均一エピウェハー 図表図7 安定生産された高均一GaAsエピウェハー / 写真1.従来ウェハー(左)と3インチ高均一エピウェハー (3)本研究の数値解析技術からの要点は大きく2つである。1つは1980年という早い時期にナビエ・ストークス方程式の解法を材料開発分野に適用したことである。ナビエ・ストークス方程式の解法に直接法を用いたが、炉の形状やプロセス条件に応じメッシュ分割の工夫により効率よく高精度の解を求める方法(図8,9)を検討し示した。図8は工夫した不等間隔メッシュでは少ない労力で細かい渦までとらえ得ること、図9は流入速度が大きければ細かな分割が必要なことを示している。また解を安定に求めるため減速緩和を行なうが、発散をさけながら緩和係数を大きくとり計算するのが効果的である(図10)ことを示した。2つは解析的方法や熱力学手法の比較的計算時間のかからない方法を併用しより実用的な手法としたことである。熱力学手法に関しては数値オーダ差の非常に大きい化学種分圧を変数とする非線型方程式を解かねばならぬが、化学種分圧の対数をとり収束領域を広げること、プロセス条件から自動的に決まる複数の化学種分圧を同時に求める多変数ニュートン・ラプソン法を採用すること等の工夫をし、従来に比べより安定な解法を考案した。表1にその有効性を示す。  図表図8 陽子分割と〓の〓(不等間隔分割) / 図9 噴出流モデルの解析結果 / 図10 噴出流モデルの緩和係数と計算時間 / 表1 様々なプロセスにおける従来法と新法の比較 図表図8 陽子分割と〓の〓(不等間隔分割) / 図9 噴出流モデルの解析結果 / 図10 噴出流モデルの緩和係数と計算時間 / 表1 様々なプロセスにおける従来法と新法の比較 (2)光ファイバ母材の経済的作製に資するプロセス解析技術の研究 我が国における光ファイバの導入は電話局間や中継所間の幹線系から始まり、1986年には北海道から沖縄までの全国縦貫システムが完成し、現在は各家庭まで光ファイバを延伸する加入者系への適用が本格化しつつある。この様に光ファイバの本格的普及には低コストでの大量生産が必須であり、これに資する数値解析技術の研究を母材作製プロセスにつき行なった。 VAD法による光ファイバ母材作製は、合成速度の向上や母材大型化が容易で低コストの大量生産に有利である。しかしバーナに関する-幾何学条件、流量条件、温度条件等のバリエーションが大変多く複雑であるに加え、高温の流体プロセスのため計測も困難である。そこで燃焼化学反応を伴なった高速流体プロセスの解析手法を開発し、原料ガスの収率向上、母材の合成速度向上に指針を与えた。 実用的見地からなるべく簡単なモデル化を行なうこととし、VADプロセスを(1)燃焼・SiO2粒子生成(2)SiO2粒子の母材への付着の2ステップに分けて考えた。(1)のステップは燃焼反応を伴なう高速流体の解析である。この様な解析は内燃機関等の研究的解析はあるものの実用的効果を挙げているものは極めて少なく、特に材料開発分野に関しては殆んど皆無である。そこでVAD反応は原料ガスSiCl4の加水分解反応であるがそれはH2Oによって律速されるものと考え、酸水素反応のみを考えた簡易モデルを解き、次いでSiCl4との反応を解くことによりSiO2濃度を求めた。これでVAD火炎の構造が分る様になりSiO2粒子生成のメカニズムの大わくが理解できた。図11に火炎中心軸上の濃度と温度の変化を示す。(2)のステップでは付着のメカニズムにつき慣性力によるモデルと熱泳動によるモデルを検討した。高精度流体解析により両モデルを評価した所、慣性力では粒径50 m以上と非現実な大きさでないと効果がないのに対し、熱泳動力では図12に示す如く現実的な粒子が流線をはなれ母材に付着することが分り、我々のプロセスでは付着は熱泳動効果によるものとして実用的には推測しうるに至った。 m以上と非現実な大きさでないと効果がないのに対し、熱泳動力では図12に示す如く現実的な粒子が流線をはなれ母材に付着することが分り、我々のプロセスでは付着は熱泳動効果によるものとして実用的には推測しうるに至った。  図表図11 H2O,SiO2濃度,温度の変化 / 図12 熱泳動力モデルによる粒子軌跡 図表図11 H2O,SiO2濃度,温度の変化 / 図12 熱泳動力モデルによる粒子軌跡 この技術により、「高速合成を達成するには原料供給量を増す必要があるが単に増すだけでは堆積効率が低下し安定な合成が出来ない。流量増加に伴ない火炎を大きくし、粒子を中心に集中させ熱泳動効果により粒子付着を促進する必要がある。」という指針を示し、複雑なVADパラメータの最適化を行ないVAD法の効率向上に寄与した。 |