| 内容要旨 | | 1.はじめに 化学気相成長(CVD)法は,気相から原料ガス分子を基板上に供給して薄膜を形成する技術であり,集積回路の製造プロセスで広く用いられている.CVDの特徴は,その成膜過程が原料ガス分子の吸着,分解などの表面化学反応を経るために,原料ガス分子の吸着座を限定した選択成長,あるいは低温成長などの表面とガス分子の不均一系触媒反応を利用した成膜が期待できる点にある.このような,CVDの特徴を生かすためには,原料ガス分子と固体表面との間でおこる化学過程を管理解する事がなににも増して重要となる.本研究では,GeのCVDにおける表面反応の過程を電子分光,昇温脱離などの表面科学的手法によって解析し,その理解を基にGe原子層エピタキシーのための表面反応設計の基本的概念を提案,実証することを目的とした. 2.GeH4を用いたGeのCVDにおける成膜特性 まず,もっとも単純なGeのガス分子であるGeH4を用いてSi(100)基板上での成膜特性を調べた.図1にGeの成膜速度のGeH4分圧依存性を示す.高温領域では成膜速度はGeH4分圧に比例する.これは成膜の律速段階がGeH4分子の表面への供給過程にあることを示しており,一般に供給律速あるいは拡散律速と呼ばれる状態に対応する.一方,低温領域ではこの様な比例関係は成立していない.つまり,この低温領域で成膜を律速するのは,GeH4分子の表面への拡散ではなく,表面にガス分子が到達してから起こる表面反応である.この表面反応律速下では,GeH4分子のラングミュア吸着を仮定すると,成膜速度は,その被覆率に比例する量として表すことができる.図中の実線はこの仮定に基づいてエピタキシャル成長したGe膜についてその成膜速度をフィッティングによって求めたものである.実測を良く再現しており成膜速度の反応速度論的取り扱いの有効性を示している. 通常,Si上でのエピタキシャル成長は,基板上に形成される自然酸化膜等のSiサブオキサイドが,高温で揮散して清浄表面が露出することによって可能となる.しかし,本検討では603Kから683Kという比較的低温でGeのエピタキシャル成長が可能であった.これは,成膜の初期に,シリコン自然酸化膜が何らかの化学反応によって除去されていることを示している.実際に,図2に示すように,H2O2中で形成したシリコンサブオキサイドの除去速度をX線光電子分光法等で調べると,GeH4分圧の1/2乗に比例することがわかる.この結果は,1分子のGeH4と2分子のSixOの反応によって自然酸化膜が除去されることを示している.低温エピタキシーを可能としている要因はこの清浄化反応にあることが示唆される.  図表図1.Ge成膜速度のGeH4分圧依存性 / 図2.酸化膜除去速度のGeH4圧力依存性3.GeCl4-H2系によるGeのCVDにおける表面反応の速度論的解析 図表図1.Ge成膜速度のGeH4分圧依存性 / 図2.酸化膜除去速度のGeH4圧力依存性3.GeCl4-H2系によるGeのCVDにおける表面反応の速度論的解析 GeH4のハロゲン置換体であるGeCl4を選びGeの成膜反応を検討した結果を次に記す.GeCl4に期待したのは,表面にこのガスが吸着したときに塩素が表面側に存在することによって,次の反応をブロックし,原子層エピタキシーの要件の一つである反応の自己停止機能を発現できないかという点である.図3にGeエピタキシャル膜の成膜速度のGeCl4分圧依存性を示す.成膜速度はGeCl4分圧の増加とともに極大を持ち,しだいに減少してゆく.この特徴は,成膜反応がラングミュア-ヒンシェルウッド過程を経ることを示している.またこのような成膜は水素の存在下でのみ可能であり,GeCl4あるいはその誘導体の吸着系と解離吸着水素との反応によって成膜が進行していることも示している.このことは水素の解離吸着能のないSiO2上ではGeは成長しないという選択成長を保証する要因ともなっている.さらにGeCl4は固体Geとの間で逆不均化反応によるエッチングを引き起こすこともわかった.すなわち,Ge膜のエッチングモードが成膜モードとともに混在しているわけである.このために当初期待した塩素の反応プロックによる成膜の自己停止機能の発現はできなかった.  図3.Ge成膜速度のGeCl4分圧依存性4.Ge(C2H5)2H2によるCVDの表面反応と吸着の自己停止機能 図3.Ge成膜速度のGeCl4分圧依存性4.Ge(C2H5)2H2によるCVDの表面反応と吸着の自己停止機能 さらにエチル基のようなかさ高い置換基と水素のような小さい原子を合わせ持つGeH4のジエチル置換体のCVDにおける表面反応を検討した.このガス系に期待したのは,この分子が成膜反応初期に表面に吸着するとき,水素が優先的に相互作用し,エチル基は表面と相互作用せずに最表面に残ることで,自己停止機能が発現することである.これは,立体障害による反応阻止効果をCVDの成膜制御に適用することを意図したものでもある.Ge(C2H5)2H2(DEGe)のCVDにおけるエピタキシャル膜の成膜速度は,4x10-1Paから1x101Paの広い圧力範囲で圧力依存性が無い.ラングミュア吸着を仮定すると,DEGeの被覆率は0.98-1.0となり吸着平衡が吸着側に大きく移動していることがわかった.図4は,Ge(100)基板上にDEGeを493Kで1x106L暴露した後の,エチル基の昇温脱離スペクトルである.スペクトルの形状は典型的な1次の脱離を示し,また,脱離の開始温度は,Geの連続成膜が始まる温度とほぼ一致している.こり事実は,エチル基の脱離温度以下でDEGeを導入すれば,エチル基をともなったGeの吸着層が高い被覆率で形成され得ることを示している.図5は493KでGe(100)基板上に吸着させたDEGeからの脱離エチル基の収量のDEGe暴露量依存性を示す.収量は広い暴露量に渡って一定である.これはこの分子系に期待した吸着の自己停止機能の発現を物語るものである. 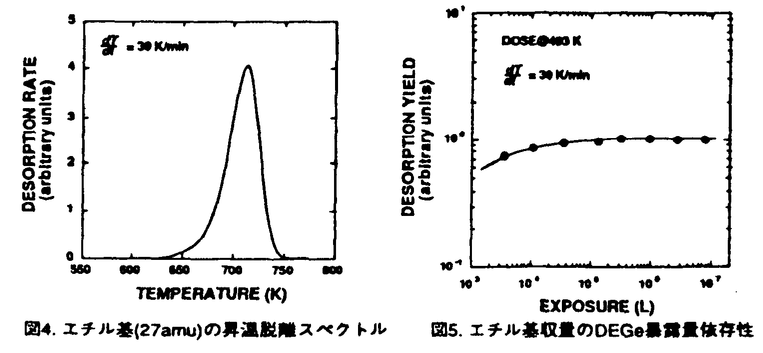 図表図4.エチル基(27amu)の昇温脱離スペクトル / 図5.エチル基収量のDEGe暴露量依存性5.Ge(C2H5)2H2によるGeの原子層エピタキシー 図表図4.エチル基(27amu)の昇温脱離スペクトル / 図5.エチル基収量のDEGe暴露量依存性5.Ge(C2H5)2H2によるGeの原子層エピタキシー 前節の検討は,図6に示すような表面反応を制御した原子層成長の可能性を示している.すなわち,この分子系を低温で吸着させると(図6a),エチル基を表面側にしてGeが吸着し(図6b),このエチル基が本来ならば次の成膜反応に参加すべきGeのダングリングボンドを終端しているために自己停止機能が発現する.このような吸着系で,エチル基を昇温脱離によって脱離させ(図6c),その後再びこのガス分子を導入する.実際に成長する膜厚は上述のシーケンスの繰返し数に比例し,1回あたりの成長膜厚は0.12nmであった.これは(100)面上でのGe原子層0.14nmにほぼ相当する値である.このように反応素過程を一段階ずつ組み合わせる型の薄膜成長法でIV族系の原子層エピタキシーを実現したのは世界初である.  図6.DEGeによるGe原子層エピタキシー6.まとめ 図6.DEGeによるGe原子層エピタキシー6.まとめ 本研究では,原子層エピタキシーの実現を目標として,GeのCVDにおける表面反応の検討を行った.その結果,Geの選択成長,原料ガスによる表面の清浄化反応などGe-CVDにおける新しい知見を得た.また,原料分子中に,その分子が吸着系を形成したとき,さらなる吸着をブロックする側鎖を作り込んでおくことによって吸着の自己停止機能を発現し,成膜素過程を制御することによって,Geの原子層エピタキシーを実現した. |
| 審査要旨 | | 本論文は9章から成るが、大きく4つに分けられる。第1章は序論、第2章〜第4章はGeH4,GeCl4-H2,Ge(CH3)4のCVD(化学気相成長)法によるGe薄膜成長、エッチング、熱分解の特性、第5章〜第7章はGe(C2H5)2H2.Ge(CH3)2H2のCVDによる原子層エピタキシャル成長の振る舞い、第8章はPt,WのCVD、そして第9章は結論である 第1章では、半導体物理学におけるGeの位置づけ、CVD法の特徴、特にGe原子層エピタキシャル成長の重要性と、本研究ではこのGeのCVD過程における原料分子の表面反応の理解とその応用に目的があることを述べている。 第2章では、GeH4のCVD成膜反応によってGe薄膜がSi表面に選択的に成長するという実験結果を述べている。そして成長速度がLangmuir吸着等温式を用いた成長パラメーターの関数で表されることも示している。また、Si表面上へのエピタキシャル成長の原因を明確にするためにGeH4によるSi表面酸化膜の除去の様子をXPSを用いて調べた結果についても述べている。 第3章では、GeCl4-H2ガス系でのエピタキシャル成長とエッチングについて述べている。動力学的研究から成長過程はLangmuir-Hinshelwood型の吸着解離反応によること、更に、Si(100)表面に吸着したGeClxはGeH4を用いたCVDによる薄膜成長の阻害剤の働きをすることも言及している。 第4章ではGe(CH3)4を用いたCVDによる薄膜成長の特性についで述べている。ここでは、Ge-CH3結合が1023 Kまで熱的に安定であり、それ以上では多結晶として成長することを示している。 第5章ではGeの原子層エピタキシィ成長を実現させるためにGeH4のジエチル誘導体の利用について述べている。即ち、エピタキシャルに成長したGe(100)表面上でGe(C2H5)2H2を反応させることによって自己停止機能を持った吸着が起こることを示している。そして、これが吸着層のエチル基による立体障害とGeダングリングボンドの終端によるとして説明している。このような新しいコンセプトによる自己停止機能を持ったGe原子層エピタキシィの実現は極めて注目に値するものである。また、吸着層からのエチル基の熱脱離機構が -水素化脱離であることも昇温脱離法の実験から調べている。 -水素化脱離であることも昇温脱離法の実験から調べている。 第6章では、Ge(C2H5)2H2の導入と残留ガスの排気、エチル基の熱脱離のサイクルを繰り返すことによって、Ge(100)上にGeをエピタキシャルに1原子層ずつ成長できることを例証している。 第7章では、Ge(CH3)2H2の表面反応について述べている。そして、この場合も自己停止機能が働くこと、メチル基を紫外線照射によって光脱離させる方法などを示している。 第8章では本研究の一つの発展としてSiH4とPtの反応を用いた新しいPtSi電極の製作、WF6を用いたSi表面上への選択的W電極の製作などの様々な応用について述べている。 最後の第9章では、全体を通しての結論として、Ge化合物による成膜の表面反応の動力学を解明したこと、CVD反応に用いる原料分子の側鎖原子団による自己停止機構を発現させたこと、そして、原料分子の表面反応素過程の制御によってGe原子層エピタキシャル成長を実証したことを指摘している。 以上を要約すると、本論文の提出者 石井 仁氏は、集積回路の製造プロセスで広く用いられているCVD法においてGeの薄膜成長を光電子分光、昇温脱離法などの表面科学的な手法によって解析し、その理解を基にして原子層エピタキシィのための表面反応設計の基本的な概念を提案し、それを実証することに成功した。この研究成果は表面科学の基礎としても、また、半導体科学への応用においても大きなインパクトを持ったものであり、今後の発展に寄与するところ大である。したがって、石井 仁氏は博士(理学)の学位を授与される資格を有するものと認める。 なお、本論文に述べられている研究成果は共著邦文の形で公表済みであり、共著者は研究の指導者、研究協力者であるが、論文提出者の寄与が最も大きいと判断される。また、共著論文の内容を学位論文にすることについては、全ての共著者の承諾を得ている。 |