| 内容要旨 | | 近年の液晶ディスプレイ(LCD)技術の発達は目覚ましいものがあるが、LCDパネルの配線材料において、従来から使用されてきた高融点金属薄膜に替わるAl合金薄膜の開発が、LCDの高精細化、大画面化の実現に重要な役割を果たしている。Al合金薄膜では低抵抗が実現できるものの、耐ヒロック性に代表される耐熱性に課題があり、少なくとも10  cm以下の低抵抗で、かつ約573K以上の製造プロセスにおいてヒロックを生じないAl合金膜の開発が必要とされている。基板上に形成された薄膜において、加熱によりヒロックが形成する現象については60年代後半から知られており、特にAl薄膜に関しては、LSI配線に用いられる0.1〜0.2at%の合金元素を添加したAlCu(Si)合金系を中心に非常に多くの報告がなされている。しかし、LCD配線に用いられるような2at%程度の高合金元素添加膜においては、これまでにない特異なヒロック形成現象が発現し、しかも耐ヒロック性改善についての系統的な検討は未だなされていない。本論文はLCD配線用のAl合金薄膜において耐ヒロック性改善のための合金設計指針を明確化することを目的として研究したものであり、特に、AlTa合金薄膜を中心とした各種Al二元系合金膜におけるヒロック形成挙動、ヒロック密度決定の支配要因、熱応力緩和挙動と耐ヒロック性の関係など、ヒロック形成と抑制現象の詳細を検討し、その成果をまとめたものである。 cm以下の低抵抗で、かつ約573K以上の製造プロセスにおいてヒロックを生じないAl合金膜の開発が必要とされている。基板上に形成された薄膜において、加熱によりヒロックが形成する現象については60年代後半から知られており、特にAl薄膜に関しては、LSI配線に用いられる0.1〜0.2at%の合金元素を添加したAlCu(Si)合金系を中心に非常に多くの報告がなされている。しかし、LCD配線に用いられるような2at%程度の高合金元素添加膜においては、これまでにない特異なヒロック形成現象が発現し、しかも耐ヒロック性改善についての系統的な検討は未だなされていない。本論文はLCD配線用のAl合金薄膜において耐ヒロック性改善のための合金設計指針を明確化することを目的として研究したものであり、特に、AlTa合金薄膜を中心とした各種Al二元系合金膜におけるヒロック形成挙動、ヒロック密度決定の支配要因、熱応力緩和挙動と耐ヒロック性の関係など、ヒロック形成と抑制現象の詳細を検討し、その成果をまとめたものである。 走査電子顕微鏡内でのヒロック形成のその場観察や、薄膜断面組織観察等により、AlTa合金薄膜に発生するヒロックの主要な特徴として以下の点が明確となった。:(1)形成初期にヒロック形成/成長サイトは決定され、加熱中および等温保持中ともにマクロなヒロック密度は変化しない、(2)Ta添加量が増加すると、ヒロック形成温度が顕著に増加する、(3)ヒロックはほぼAl原子により構成された純Al多結晶組織である、(4)配線形状にパターンニングされた膜においては、配線上端部にサイドヒロックを形成しやすい。 ヒロック密度は耐ヒロック性を評価する尺度として一般的に用いられており、従来、ヒロック形成サイトとなる粒界三重点や表面欠陥をヒロック密度を決める支配要因とするモデルが知られている。そこで、合金化による耐ヒロック性の変化を、ヒロック形成サイトの観点から検討した。 図1は573Kにて1時間熱処理したAlCuおよびAlTa合金膜における平均ヒロック間距離と結晶粒径の合金元素添加量依存性を示したものである。AlCu合金膜ではヒロック間距離のCu量依存性は認めれなかったが、AlTa合金膜ではTa添加量を増やすと、ヒロック密度が急激に減少し、それに伴いヒロック間距離は数 mから約100 mから約100 mまで増加した。ヒロック間距離はいずれの場合も結晶粒径に比して1桁から3桁大きかった。つまり、膜中には非常に多くの形成可能サイトのが存在することに対して、実際のヒロックはその極く一部のサイトのみに形成しており、形成サイトと薄膜組織との相関は認められなかった。 mまで増加した。ヒロック間距離はいずれの場合も結晶粒径に比して1桁から3桁大きかった。つまり、膜中には非常に多くの形成可能サイトのが存在することに対して、実際のヒロックはその極く一部のサイトのみに形成しており、形成サイトと薄膜組織との相関は認められなかった。  図1 Al2at%TaおよびAl2at%Cu合金膜において573Kで生じたヒロックの平均ヒロック間距離と結晶粒径の合金元素添加量依存性 図1 Al2at%TaおよびAl2at%Cu合金膜において573Kで生じたヒロックの平均ヒロック間距離と結晶粒径の合金元素添加量依存性 次に最小木解析(MST)法を用いたヒロックの空間分布パターンの定量評価により、合金系によるヒロック形成サイトの相違を示す。図2はAl2at%Cu、Al0.5at%Ta、およびAl2at%Ta合金膜において、MST法により得られた規格化ヒロック間距離mとその標準偏差 の関係である。AlCuおよびAlTa膜のヒロック分布はいずれも均一ランダム分布に相当した。これはヒロック密度に顕著な違いがあっても、形成サイト選択においては同じメカニズムが作用していることを示唆している。しかし、Ta添加量を増加させると の関係である。AlCuおよびAlTa膜のヒロック分布はいずれも均一ランダム分布に相当した。これはヒロック密度に顕著な違いがあっても、形成サイト選択においては同じメカニズムが作用していることを示唆している。しかし、Ta添加量を増加させると が減少し、ヒロック分布の規則度が増加し、一定距離内にヒロック同士が近付けない排他律が作用している傾向が認められた。 が減少し、ヒロック分布の規則度が増加し、一定距離内にヒロック同士が近付けない排他律が作用している傾向が認められた。 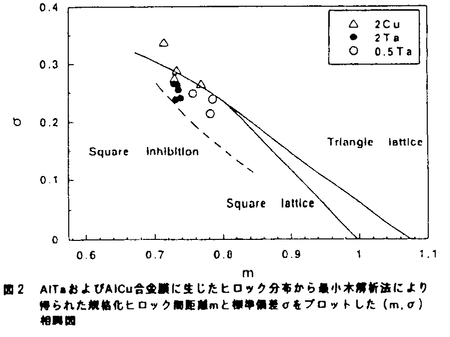 図2 AlTaおよびAlCu合金膜に生じたヒロック分布から最小木解析法により得られた規格化ヒロック間距離mと標準偏差 図2 AlTaおよびAlCu合金膜に生じたヒロック分布から最小木解析法により得られた規格化ヒロック間距離mと標準偏差 プロットした(m, プロットした(m, )相関図 )相関図 さらに、スパッタ酸化膜と陽極酸化膜をAlTa合金膜の表面にキャップ層として形成し、表面欠陥とヒロック形成サイトとの関係を検討した。2種類の酸化膜キャップ層は、異なる表面欠陥状態を作り、ヒロック形成挙動に変化を与えることが期待されたが、100nm程度までの酸化膜厚では、膜厚や膜種に関係なく、合金系固有のヒロック密度を呈した。また、膜表面の欠陥の存在に関係なく、キャップ層と金属膜の界面にヒロックは優先的に形成し、その体積の増加に伴ってキャップ酸化膜を突き破る様に形成し、表面状態に関係なく、ヒロック密度が合金系に応じて決定されることが明確となった。 以上のように、合金化によるヒロック密度の変化で示される耐ヒロック性改善に対して、膜組織や表面欠陥に基づく形成サイトとの相関は認められなかった。しかし、キャップ層によるヒロック形成の抑制にはある程度のキャップ層厚が必要であることから、2層膜の応力温度曲線を解析すると、キャップ層を含む2層膜における初期応力と、機械的性質の複合則から導かれる剛性に依存して加熱時に膜に発生する熱応力量が変化し、これから耐ヒロック性が説明することができた。そこで、LCD配線用Al合金薄膜に発生するヒロックの主要な特徴であるサイドヒロック形成、低ヒロック密度についても膜応力との関係から検討した。 パターンニングされたAl薄膜に発生する熱弾性応力を計算すると、図3に示すように配線エッジ部の限られた領域において顕著な応力勾配が生成し、特に加熱時にこの勾配が大きくなる合金系や、低温成膜条件、熱処理条件でサイドヒロックが形成されることがわかった。また、平均ヒロック間距離を用いて、ヒロックが緩和する応力量を概算すると、AlCuとAlTaではヒロックサイズや密度が顕著に異なるものの、応力緩和量としてはいずれも約100Mpaと同等もしくは、ヒロックサイズが小さいAlCuにおいて応力緩和量はむしろ大きくなった。この結果は、ヒロックはヒロック周辺の局所的な領域の応力を緩和し、ヒロック間の領域では結晶粒成長や塑性変形など他の機構により応力が緩和されるという従来のモデルに対し、ある条件下ではヒロック形成が膜応力緩和の主要因となり、膜中の広い領域の応力が一つのヒロックにより緩和されることを示唆している。また、このようなヒロックによる応力緩和では膜組織の影響が大であり、AlTa合金膜では基板/膜界面における微結晶層の存在が、膜面方向の原子拡散を促進し、ヒロック密度の低下に重要な役割を果たしていると考えられる。  図3 400nm厚-50 図3 400nm厚-50 m幅のAl膜を573Kに加熱した場合に各膜厚部tにおいて配線エッジ近傍に発生する熱弾性応力ブロファイル m幅のAl膜を573Kに加熱した場合に各膜厚部tにおいて配線エッジ近傍に発生する熱弾性応力ブロファイル 合金元素添加によるAl薄膜の耐ヒロック性改善が膜応力要因により大きな影響を受けていることが明らかとなり、さらに応力温度曲線を用いて各合金膜の耐ヒロック性の限界温度を推定することを検討した。Al合金膜は図4に示すように応力温度曲線に現れる応力緩和挙動によりA,B,Cの3グループに分類され、特に、BおよびCに含まれる合金系で高い耐ヒロック性が期待できる。このような応力緩和挙動は添加元素の析出挙動と密接な関連を持つが、応力緩和開始温度や緩和応力量の加熱速度依存性から、7aおよび8族元素の属するグループBでは、各合金系で特徴的な温度域において、それまでの加熱で生じた大半の熱応力が塑性流動を主要因として緩和されることがわかった。このため、この急激な圧縮応力緩和が終了するまでの温度域で耐ヒロック性が確保される。それ以上の温度域に加熱した場合には、新たに発生する熱応力を緩和するように小サイズのヒロックが高密度に発生し、さらにサイドヒロックよりも表面ヒロックが形成されやすい。4a、5a、6a元素が主に属するグループCでは図5のAlTa膜の例に示すように応力緩和開始温度とヒロック形成温度はほぼ一致し、ヒロック形成を主要因として応力緩和が進行すると考えられる。このため、応力温度曲線が直線関係を示す弾性変形温度域内でのみ耐ヒロック性が確保される。この合金系では、応力緩和開始温度が顕著な添加元素種、添加量依存性を示し、また、ヒロック発生時の膜応力が高く、比較的サイズの大きなヒロックが低密度に発生し、サイドヒロックが形成されやすい特徴を示す。  図4 Al二元系合金膜において加熱時の圧縮応力緩和挙動に基づき3分類される応力温度曲線 図4 Al二元系合金膜において加熱時の圧縮応力緩和挙動に基づき3分類される応力温度曲線 図5 AlTa合金属におけるヒロック形成温度と応力緩和開始温度のTa添加量依存性 図5 AlTa合金属におけるヒロック形成温度と応力緩和開始温度のTa添加量依存性 本研究の結果として、合金元素添加によるAl合金薄膜における耐ヒロック性の向上は、ヒロック形成サイトに起因するものなく、膜応力に強く依存したものであることが明確となった。これにより、Al二元系合金薄膜の応力温度曲線から耐ヒロック温度を推定し、合金設計や積層構造設計をおこなう指針が確立された。そして、図6に示すように各合金系における元素添加量に依存した比抵抗値と耐熱温度限界の関係が求められ、この図はLCD配線に留まらず、比抵抗と耐熱性の両特性が求められる各種アプリケーションに対してAl合金膜を適用する場合に有用である。 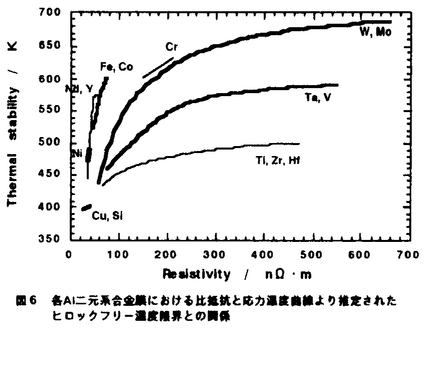 図6 各Al二元系合金膜における比抵抗と応力温度曲線より推定されたヒロックフリー温度限界との関係 図6 各Al二元系合金膜における比抵抗と応力温度曲線より推定されたヒロックフリー温度限界との関係 |
| 審査要旨 | | 液晶ディスプレイ(LCD)の高精細化・大画面化にLCDパネル配線材料の果たす役割は大きい.高融点金属薄膜に替わりAl合金薄膜が開発・実用化されてきたが,耐ヒロック性に代表される耐熱性に課題があり,10  cm以下の低抵抗かつ約573K以上の製造プロセスにおいてヒロックを生じないAl合金膜の開発が必要とされている.本論文はLCD配線用のAl合金薄膜において耐ヒロック性改善のための合金設計指針を明確にすることを目的に,AlTa合金を中心とした各種Al二元系合金膜におけるヒロック形成挙動,ヒロック密度決定の支配要因,熱応力緩和挙動と耐ヒロック性の関係など,ヒロック形成と抑制現象を詳細に検討したもので8章より成る. cm以下の低抵抗かつ約573K以上の製造プロセスにおいてヒロックを生じないAl合金膜の開発が必要とされている.本論文はLCD配線用のAl合金薄膜において耐ヒロック性改善のための合金設計指針を明確にすることを目的に,AlTa合金を中心とした各種Al二元系合金膜におけるヒロック形成挙動,ヒロック密度決定の支配要因,熱応力緩和挙動と耐ヒロック性の関係など,ヒロック形成と抑制現象を詳細に検討したもので8章より成る. 第1章は緒言であり,本研究の背景・目的を述べた.第2章は本研究で採用した実験法について,試料作成・調整法から各種評価法について述べた. 第3章では,Al合金薄膜を加熱する際に発生するヒロックの主要な特徴を走査電子顕微鏡内でのその場観察や薄膜断面組織観察等により検討し,以下の点を明らかにした.(1)形成初期にヒロック形成/成長サイトは決定され,加熱中および等温保持中ともにヒロック密度は変化しない,(2)Ta添加量が増すと,ヒロック形成温度が顕著に増加する,(3)ヒロック内の溶質濃度はAlCuにおいては母相とほぼ同一であるが,AlTa合金薄膜においてはAl原子により構成された純Al多結晶組織である,(4)配線形状にパターンニングされた膜においては,配線上端部にサイドヒロックを形成しやすい. 第4章ではAlCuおよびAlTa合金膜におけるヒロック密度と微細組織の関係を検討した.AlCu合金膜ではヒロック間距離のCu量依存性は認めれなかったが,AlTa合金膜ではTa添加量を増やすと,ヒロック密度は急激に減少した.ヒロック間距離はいずれの場合も結晶粒径に比して1桁から3桁大きかった.ヒロックは形成可能サイトの一部のみに形成され,形成サイトと薄膜組織の相関は認められなかった.最小木解析法を用いたヒロックの空間分布パターンの定量評価により,AlCuおよびAlTa膜のヒロック分布はいずれも均一ランダム分布に相当した.これはヒロック密度に顕著な違いがあっても,形成サイト選択においては同じメカニズムが作用していることを示唆している. 第5章ではAlTa合金膜の表面にキャップ層としてスパッタ酸化膜と陽極酸化膜を形成し,表面欠陥とヒロック形成サイトとの関係を検討した.100nm程度までの酸化膜厚では,膜厚や膜種に関係なく,合金系固有のヒロック密度を呈した.膜表面の欠陥の存在に関係なく,キャップ層と金属膜の界面にヒロックは優先的に形成され,その成長に伴ってキャップ酸化膜を突き破る様に発達した.ヒロック密度は表面状態・膜組織や表面欠陥に基づく形成サイトに関係なく合金系に応じて決定される,ことが明らかにされた.キャップ層によるヒロック形成の抑制にはある程度のキャップ層厚が必要であることから,2層膜の応力温度曲線を解析すると,キャップ層を含む2層膜における初期応力と,機械的性質の複合則から導かれる剛性に依存して加熱時に膜に発生する熱応力量が変化し,これから耐ヒロック性が説明できた. 第6章ではサイドヒロック形成,低ヒロック密度について膜応力の関係から検討した.パターンニングされたAl薄膜に発生する熱弾性応力を計算すると,配線エッジ部の限られた領域において顕著な応力勾配が生成し,加熱時にこの勾配が大きくなる合金系や,低温の成膜条件や加熱条件でサイドヒロックの形成が予測された.また,平均ヒロック間距離から,ヒロックによる緩和応力量は,AlCuとAlTaではいずれも約100MPaと同等もしくはヒロックサイズが小さいAlCuにおいてむしろ大きくなった.この結果は,ヒロックはヒロック周辺の局所的な領域の応力を緩和し,ヒロック間の領域では結晶粒成長や塑性変形など他の機構により応力が緩和されるという従来のモデルに対し,ある条件下ではヒロック形成が膜応力緩和の主要因となり,膜中の広い領域の応力が一つのヒロックにより緩和されることを示唆している.ヒロック生成による応力緩和では膜組織の影響が大きく,AlTa合金膜では基板/膜界面における微結晶層の存在が膜面方向の原子拡散を促進し,ヒロック密度の低下に重要な役割を果たしていると考えられる. 第7章では,応力温度曲線から合金元素添加による各Al薄膜の耐ヒロック性の限界温度を推定した.応力温度曲線に現れる応力緩和挙動によりAl合金膜は3グループに分類され,2つのグループの合金系で高い耐ヒロック性が期待できる.応力緩和開始温度や緩和応力量の加熱速度依存性から,7aおよび8族元素の属するグループでは,各合金系で特徴的な温度域において,加熱で生じた大半の熱応力が塑性流動を主要因として緩和される.このため,この急激な圧縮応力緩和が終了するまでの温度域で耐ヒロック性が確保される.4a,5a,6a元素が主に属するグループでは,応力緩和開始温度とヒロック形成温度はほぼ一致し,ヒロック形成を主要因として応力緩和が進行する.このため,応力温度曲線が直線関係を示す弾性変形温度域内でのみ耐ヒロック性が確保される. 第8章は総括である.本研究は,耐ヒロック性の向上は膜応力に依存することを明らかにし,Al二元系合金薄膜の応力温度曲線から耐ヒロック温度を推定し,合金設計や積層構造設計をおこなう指針を確立し,LCD配線に留まらず,比抵抗と耐熱性の両特性が求められる各種アプリケーションに有益である. よって本論文は博士(工学)の学位請求論文として合格と認められる. |